MEMS科普 |金属材料添加工艺解析(三):物理气相沉积之溅射技术——动量驱动的普适性薄膜沉积
在半导体互连、MEMS微结构、先进封装与光学镀膜的广阔舞台上,溅射作为物理气相沉积的核心技术之一,以其材料普适性、合金保形性与薄膜致密性,成为现代微纳制造中应用最为广泛的金属薄膜制备工艺。
所谓溅射,即通过加速离子流(通常选用氩离子)对固态靶材进行轰击,致使靶材原子因动量交换而被“敲击”出来,随即以蒸气形态迁移并凝结在附近的衬底上。这一物理过程依赖于高真空环境:所有组件(含阴阳极、靶材及衬底)均封装于不锈钢腔室中,先抽真空10-6Torr以下的本底压力,再回填氩气至 1~10 mTorr 的工作压强。在电场作用下氩气发生电离,依据施加电压波形的特性,该技术被界定为直流(DC)溅射或射频(RF)溅射。
为了确保生成的金属膜层厚度均匀,工艺中常采用基片旋转法,转台转速一般设定在 10 至 30 转/分之间。值得注意的是,薄膜的生长速率是一个变量,它与靶衬距离、离子的能量与种类、以及靶材品质等关键参数密切相关。
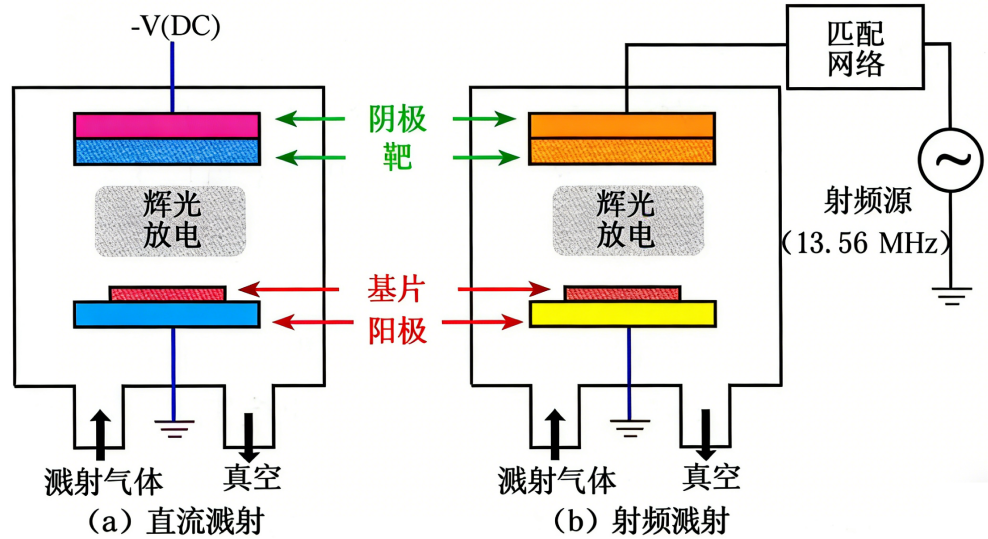
1)直流溅射(DC Sputtering)
针对铝、钛、铜、金、钨等导电金属材料的薄膜制备,通常采用直流电源激发离子轰击阴极靶材。如图(a)所示,直流溅射系统核心组件包括直流电源、作为阴极的金属靶、高压氩等离子体发生源以及承载晶圆衬底的阳极。其工作原理是:在负偏压作用下,氩离子撞击金属靶面,致使靶材原子剥离并迁移沉积至衬底表面。虽然提高溅射功率可显著提升淀积速率,但过高的功率可能导致基材损伤。为解决这一矛盾,常引入磁控溅射技术:通过在靶材背部增设磁铁构建磁场,约束电子在靶面附近运动,从而在不增加电压的前提下大幅提高氩气电离效率,实现高效淀积。
2)射频溅射(RF Sputtering)
如图(b)所示,射频溅射系统以射频电源替代了传统的直流电源。尽管该系统仍需直流偏置来维持等离子体,但氩离子的加速主要依赖交流电场驱动。工业上普遍采用13.56 MHz作为工作频率(ISM频段)。由于交流电能够穿透绝缘介质,射频溅射不仅适用于导体,更广泛应用于二氧化硅、氮化硅及玻璃等介电材料的成膜,有效克服了介电材料因电荷积累(充电效应)而无法进行直流溅射的局限。此外,通过反转电气连接,可利用等离子体轰击衬底而非靶材,实现衬底表面的原位清洗。
3)台阶覆盖特性(Step Coverage)
与蒸发工艺相比,溅射技术在非平整表面的保形涂覆方面表现更为优异,这对三维MEMS器件金属化及集成电路互连至关重要。然而,在通孔结构中,溅射存在明显的厚度不均匀性:通孔侧壁上部的淀积速率远高于下部,导致侧壁薄膜呈现“上厚下薄”的梯度分布。对于高深宽比通孔,受限于质量传输效应,入口处易形成狭窄瓶颈并产生高压屏蔽,致使底部难以沉积金属。总体而言,深宽比越大的沟槽或通孔,其台阶覆盖效果越差。
为改善台阶覆盖能力,主要采取两种策略:一是通过加热衬底增强原子的表面扩散;二是施加RF偏置利用离子轰击诱导侧壁材料的再沉积。前者更适用于耐高温绝缘层(如SiO2)的集成电路工艺;但对于由不耐温聚合物构成的三维MEMS结构,加热法受到限制。因此,高深宽比MEMS结构的均匀金属化仍是技术难点,化学镀(Electroless Plating)可能是解决此类聚合物结构金属化的有效替代方案。
核心溅射技术类型对比
工作 机理 | 典型工 艺参数 | 适用 材料 | ||
DC溅射 | 直流电场加速离子轰击导电靶材 | 功率:0.5-5 kW 电压:300-1000 V 气压:1-10 Pa | 导电材料(Al、Ti、Cu、Mo、W) | 设备简单;无法溅射绝缘材料;靶材需良好导电性 |
RF溅射 | 13.56 MHz射频场在靶表面产生自偏压 | 功率:0.5-2 kW 自偏压:-200 ~ -1000 V 需匹配网络 | 绝缘材料(SiO₂、Al₂O₃、Si₃N₄、压电薄膜) | 可溅射任何材料;沉积速率低于DC;设备成本较高 |
磁控溅射 | 磁场约束电子延长等离子体路径 | 磁场强度:200-500 G 靶电流密度:10-50 mA/cm² 沉积速率:20-200 nm/min | 金属、合金、化合物(工业标准) | 工业主流技术;高沉积速率;低衬底温度;靶材利用率需优化 |
反应溅射 | 溅射金属+活性气体原位反应 | 气体比例:Ar/O₂或Ar/N₂可调 分压控制:±1%精度 | 氧化物(TiO₂、ITO)、氮化物(TiN、TaN、AlN) | 化合物薄膜原位合成;需精确控制靶中毒现象 |
离子束溅射 | 独立离子源轰击靶材 | 离子能量:500-1500 eV 束流密度:0.1-2 mA/cm² 真空度:<10⁻² Pa | 高精度光学薄膜、磁性多层膜 | 独立控制离子能量与方向;薄膜质量最高;沉积速率低 |
与蒸发技术的本质差异
溅射沉积 | 热蒸发 | ||
粒子能量 | 1-10 eV(高能) | 0.1-0.3 eV(低能) | 溅射原子经级联碰撞获得动能 |
薄膜致密度 | 高(理论密度95-100%) | 中等(80-95%) | 高能粒子轰击消除孔隙 |
附着力 | 优异(>100 MPa) | 中等(30-70 MPa) | 界面混合效应 |
台阶覆盖 | 中等(20-50%深宽比) | 差(<10%) | 粒子散射改善各向同性 |
内应力 | 可控(-500 ~ +500 MPa) | 较高张应力 | 轰击效应与热效应平衡 |
合金成分 | 保形转移 | 分馏效应显著 | 溅射产额差异小于蒸汽压差异 |
关于我们
赛微电子是以MEMS纯代工模式为理念、特色工艺和制造能力为基础、国际化运营为侧重的半导体专业服务厂商。公司通过长期积累掌握MEMS制造核心工艺技术,并努力向硅光、射频、模拟等特色工艺技术进行延伸拓展;公司同时向客户提供IC设计服务及EDA工具服务,MEMS等特色工艺开发、集成、晶圆制造及封装测试服务。公司服务客户包括硅光子、激光雷达、运动捕捉、光刻机、DNA/RNA测序、高频通信、AI计算、ICT、红外热成像、计算机网络及系统、社交网络、新型医疗设备厂商以及各细分行业的领先企业和众多知名芯片设计公司,涉及代工和服务芯片品类范围覆盖了通信计算、生物医疗、工业汽车、消费电子等诸多应用领域。公司已初步构建MEMS封装测试能力,前瞻性布局IC设计服务及EDA工具服务,致力于为客户提供从设计服务及EDA工具、工艺开发、晶圆制造到封装测试的一站式综合服务,并将着重立足本土,拓展国际化运营。
欢迎联络
市场销售
邮箱:marketing@smeiic.com
电话:010-87018180
其他咨询
邮箱:smeiic@smeiic.com
电话:010-87018118
- 收藏




