MEMS科普 | 晶圆制造基础工艺解析(五):溅射-淀积二氧化硅——物理气相沉积的介质薄膜技术
在需要高纯度、无氢掺杂及低温工艺集成的特殊应用场景中,溅射法沉积二氧化硅技术以其独特的物理转移机制,为半导体和MEMS器件提供了化学成分精确可控的绝缘介质层。
溅射 SiO2薄膜与 PECVD SiO2薄膜很相似,这是因为这些薄膜均是电绝缘体和非晶的微结构。溅射生成的SiO2薄膜的溅射温度可低至 200℃,使它们在后端工艺中非常有吸引力。SiO2薄膜中的残余应力可以是压应力和张应力两种,而张应力往往都非常大。溅射生成的SiO2薄膜的刻蚀速率由RF功率和腔压决定。结果发现,刻蚀速率在缓冲HF中在130~750nm/min的范围变化。在KOH中刻蚀速率的范围为3.5~5.0nm/min,而在 EPW中为0.25~0.6nm/min。溅射生成的 SiO2薄膜已经成功地用作硅-硅键合的中间层,它们也可用于表面和体微机械加工制作的悬浮悬臂梁和微桥中。在悬臂梁的情况中,薄ZnO薄膜作为牺牲层。
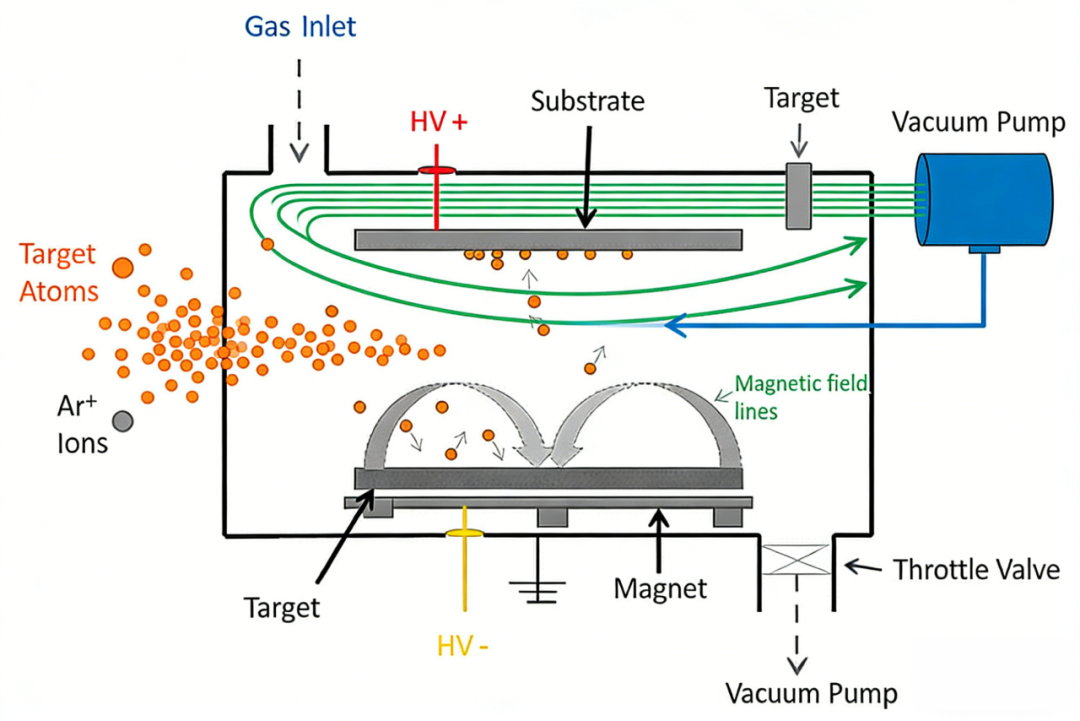
溅射真空腔体示意图
原理
Part.1
该方法基于高真空环境,通过电场加速惰性气体离子(如氩离子)轰击二氧化硅靶材,使靶材表面的原子获得能量后脱离,并在衬底上沉积形成氧化硅薄膜。
优点
Part.2
01
沉积温度较低:可在较低温度下完成薄膜沉积,减少对衬底的热影响,适用于塑料、有机材料等温度敏感材料,从而扩展了MEMS器件可用的衬底范围。
02
薄膜成分可调控:通过选用不同组成的靶材,可制备含有特定杂质或合金元素的氧化硅薄膜,例如掺入氮、钛等元素,获得氮氧化硅或钛掺杂氧化硅等功能薄膜,以适应不同MEMS器件的性能需求。
03
薄膜纯度高:该过程为物理沉积,避免化学反应引入杂质,所制备的氧化硅薄膜纯度较高,有助于提升MEMS器件的性能与稳定性,尤其适用于传感器、光学器件等对薄膜纯度要求严格的应用场景。
缺点
Part.3
01
设备投入大:需配置高真空系统、溅射电源及靶材等,初期投资及后续维护成本较高,包括定期更换靶材和保持真空系统运行。
02
沉积速率较慢:相比PECVD等技术,溅射法沉积速率较低,在大规模生产中可能影响效率,制备较厚薄膜时需要更长时间,制约了其在某些领域的应用。
03
台阶覆盖性有限:对于具有高深宽比或复杂三维结构的MEMS器件,该方法难以实现均匀覆盖,薄膜在台阶处的均匀性可能不如CVD或PECVD,致密性不如热氧化方法,从而影响器件性能与可靠性。
应用
Part.4
01
MEMS传感器防护层:在压力、气体等MEMS传感器表面沉积氧化硅膜,可增强其硬度、耐磨性与化学稳定性,保护敏感元件免受环境损害,延长使用寿命,如在工业压力传感器中抵抗油污、灰尘等污染物。
02
光学MEMS器件中的功能膜层:在微镜阵列、光波导等光学MEMS器件中,该薄膜可作为光学涂层,通过精确调控其折射率与厚度,实现对光反射、透射等性能的优化,提升器件在光通信、成像等应用中的表现。
03
MEMS绝缘层:在对绝缘性能和热稳定性要求较高的MEMS器件(如射频MEMS)中,高纯度的氧化硅薄膜可作为绝缘层,有效隔离电路区域,防止漏电,保障信号传输质量。
- 收藏




