原子级制造测量与表征研究现状综述
居冰峰1 姜 澜2 孙立涛3 陈远流1 胡 洁2
韩伟娜2 徐 涛3 刘大猛4 杨 琛5 张军辉1,6
唐金岩1 孙靖雅2 郭宝山2
1.浙江大学 流体动力基础件与机电系统全国重点实验室,杭州 310027
2.北京理工大学 机械与车辆学院,北京 100081
3.东南大学 电子科学与工程学院/集成电路学院,南京 211189
4.清华大学 高端装备界面科学与技术全国重点实验室,北京 100084
5.浙江大学 杭州国际科创中心,杭州 310058
6.国家自然科学基金委员会 工程与材料科学部,北京 100085
居冰峰 浙江大学求是特聘教授、博士生导师,“长江学者”特聘教授,国家杰出青年科学基金 获得者。主要研究方向为超精密加工技术、微纳测量以及精密机电系统等,共发表SCI论文150余篇,获得授权国家发明专利36件,以第一完成人获得浙江省技术发明奖一等奖1项、中国机械工业科学技术奖一等奖2项。

[摘 要] 原子级制造是指将能量作用于原子,通过原子级材料的可控去除或者原子/分子级结构的大规模操控及组装,实现产品性能与功能跃迁的前沿制造技术,是一种可以大规模、批量化的先进制造技术。该过程需要在10-10 m 空间尺度下精确操控原子。同时,制造过程中原子的键合时间、电子动力学变化均发生在飞秒(10-15s)至阿秒(10-18s)量级。因此,只有具备超快时间和空间分辨在线检测与表征能力,才能够深入了解并利用原子级制造过程中原子尺度的新原理、新效应,保障原子级制造的可达性与可控性;只有实现原子级制造过程的高通量、大范围的在线监测,才能保障原子级制造的可靠性。基于此,原子级制造的测量与表征是指在原子级的时间、空间、能量尺度上对材料、结构或器件进行精确的测量和表征,以保障原子级制造的可达性、可控性与可靠性。本文介绍了原子级制造所需的测量表征手段的研究现状,从原子级超快动力学过程观测、原子结构演变原位表征、原子级制造过程在线质量监测三大方向进行系统梳理,总结了目前原子级制造测量与表征的挑战并针对未来发展给出建议。
[关键词] 原子级制造测量与表征;超高时空分辨;原子结构演变动态表征;原子级制造过程在线监测
DOI:10.16262/j.cnki.1000-8217.2024.01.006
原子级制造是指将能量作用于原子,通过原子级材料的可控去除或者原子/分子级结构的大规模操控及组装,实现产品性能与功能跃迁的前沿制造技术。原子级制造过程的实时观测与动态表征是获取加工对象物质结构变化、动态行为演化和关联交互作用等关键信息的重要手段,为深入理解原子尺度上制造过程的内在机理、提取统计规律奠定了核心基础,同时对于保障原子级结构和器件的可控制造具有重要意义。借助具有高时空分辨的电子显微技术,研究人员可以直接观察到材料的形貌、晶体结构以及晶界等微观特征的变化;而以扫描隧道显微
镜为代表的探针测量技术则能够实时监测待加工表面原子的位置、运动和相互作用等。这些实时观测手段为理解制造过程中物质结构的变化规律提供了最直接的依据。同时,动态表征也能够帮助研究人员了解加工对象的动态行为演化。例如,通过光谱分析技术,可以实时监测和分析物质的能级变化、电子激发与复合过程等;而超快光学技术则可以提供极高的时间分辨率,用于观测和研究快速动态过程,如光激发、能量传递、电荷传输等。此外,制造过程中不同物质之间可能发生复杂的相互作用和界面反应等,对于制造的结果产生重要影响。利用散射技术、光电子能谱等手段,可以实时观测交互作用的发生和变化,从而了解加工对象及其与周围环境或其他材料之间的相互作用情况。在此基础上,研究原子级制造过程的在线检测与控制技术是优化制造过程、分析失效和缺陷原因、提升器件性能的必经之路。通过对制造过程测量与表征所获取的数据进行分析和挖掘,进而建立有效的统计预测模型,有望规避原子尺度制造机理复杂、难于建模的难题,并最终保障大规模器件制造的可靠性与一致性。因此,面向原子级制造的实时观测与动态表征是原子级制造研究体系中重要的研究内容之一。
本文全面回顾了原子级制造测量和表征的现有方法,结合近期国内外研究进展对现有技术方案进行了梳理总结。针对原子级制造对超精密测量和表征的新需求,重点关注原子级超快动力学过程观测、原子结构演变原位表征以及制造过程在线质量监测三个前沿方向,系统阐述了上述方向中最具代表性的测量与表征方法的核心原理、关键技术和应用价值,并对未来发展提出了建议。
1 原子级制造测量与表征的研究意义
当制造对象从“纳米”尺度步入“原子”尺度,对制造过程的测量与表征技术提出了更高的要求。如图1所示,

相比于纳米制造,原子级制造有如下特点:从时空尺度上,原子级制造需要在10-10 m 空间尺度下精确操控原子;原子级制造过程涉及原子核外电子密度的动态变化和重新分配,而电子动力学变化时间 尺 度 极 短,可 短 至 飞 秒 (10-15 s)至 阿 秒(10-18s)量级,考虑到测量通常比制造要具备更高的时空分辨率,其对探测表征装置的分辨能力和精度要求十分苛刻;原子级制造面临着从经典力学到量子理论、从线性到非线性、从平衡态到非平衡态等的跨越,涉及光子、电子、声子等载能粒子质能传输过程,其耦合作用及量子效应凸显,蕴含了大量新原理、新技术,需要毫电子伏分辨的能量测试技术揭示原子级制造过程中的质能传输原理;在原子级制造中,一个原子的错排就可能影响整个产品的性能,要保障将原子尺度的性质保持到宏观尺度的跨尺度制造良率,就需要制造过程的跨尺度在线监测手段,实现形状、性质、能量等多参量多维度的测量表征。因此,原子级制造的测量与表征成为原子级制造过程理论揭示、过程优化与精度/品质可靠性保障的核心基础。其关键在于如何在电子、原子和分子层面,实现原子级制造过程中光子—电子—声子相互作用的超快观测、动态表征与过程监测。通过建立以上原子级测量表征能力,最终保障原子级簇制造、原子/原子层 操控、原子精度制造三 大制造过程的可靠实施。
2 原子级制造测量与表征研究现状
2.1 原子级制造的可达性保障:超快动力学过程测量
原子级制造涉及载能粒子的超快时间尺度、极小空间尺度、多维度及跨尺度等动力学过程,对其实时在线观测技术的研发和设计,能够为原子级制造方法在各种极端制造情景中的加工调控机理提供必不可少的研究手段,保障原子级制造的可达性。原子级制造过程中主要涉及原子、电子状态变化,而外层电子状态变化决定了材料的物理、化学等一系列材料特性,是决定原子级制造过程的核心关键因素。电子相互作用发生在飞秒甚至阿秒时间尺度,空间精度趋于纳米乃至亚纳米量级,在分子、原子、电子层面实现联合时间域和空间域的多维连续观测技术,对于揭示原子级制造新原理、新效应至关重要。超快科技(例如超快光学和超快电学等)的发展使得载能粒子的超快动力学测量和调控成为可能,实现直接探测原子尺度下材料界面电声子的超快能量耗散过程,揭示以电子声子为能量载体的新奇量子现象。
1988年美国加州理工大学[1]利用泵浦探测实现了当时世界上最快的照相技术,观测了化学反应中电子状态的变化过程,该成果获得超快激光领域的3项诺贝尔奖之一;2010年该研究组又提出了高时空分辨率的四维超快电子显微镜观测系统[2]。2022年,加州大学[3]利用太赫兹泵浦探针对单个分子进行相干性测量,实现亚埃级化学环境异质性的可视化。如图2至图4,
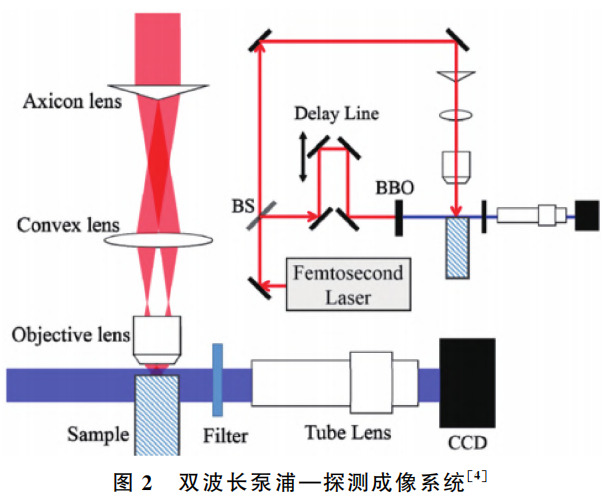
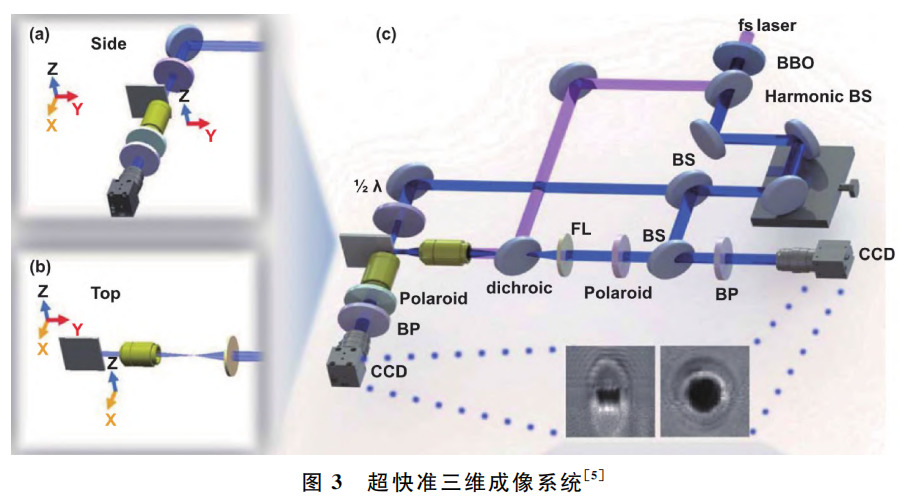
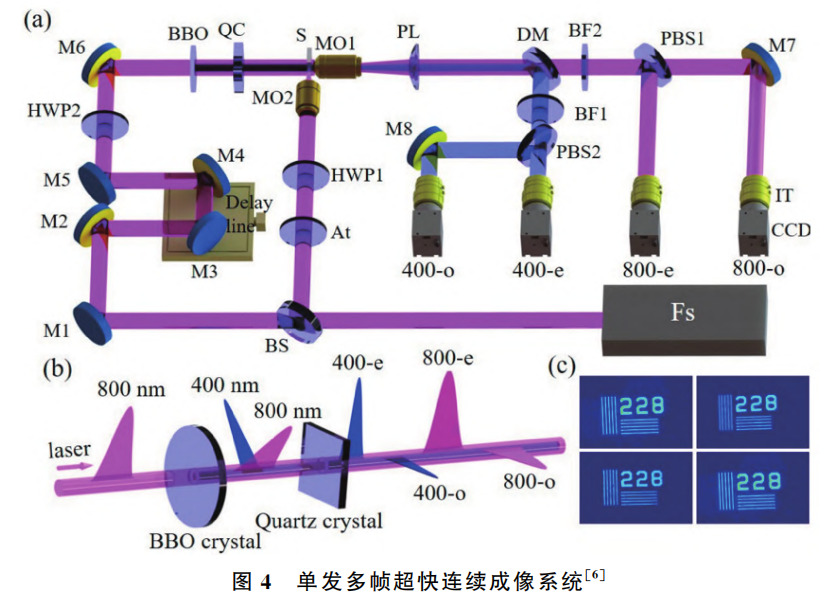
我国北京理工大学[4]2012年率先提出了跨越fs~s,15个时间数量级的多尺度观测系统,近年来,该课题组还提出了多视角多频光场重构技术,率先实现了准三维超快成像[5],以及多频多帧超快连续成像[6]。该组提出了双波长泵浦探测方法,实验测定了电子弛豫时间,攻克了等离子
体物理及超快科技的核心挑战之一,详细观测分析了飞秒激光对材料电子动态的调控过程及其演化规律,发现了超快激光辐照下光子—电子—声子的超快动力学演化规律,包括电子激发、电子电离、电子弛豫、电荷转移、冲击波动态、材料相变等系列演化机制[7-10],揭示了激光时空整形对材料成形成性的调控机制。提出了载能粒子超快动力学观测—调控一体化加工新技术[11],首次实现了制造中载能粒子超快动力学的观测与调控,大幅提升了激光加工的质量、效率和精度,质量去除精度提升了4个数量级,为国家重大工程/型号提供了全新观测能力与关键制造支撑[12-14]。德国基于热发射电镜及法国基于冷场发射电镜研发的超快透射电子显微镜在正空间成像、倒空间电子衍射图等应用中均可达到飞秒级分辨率[15-17]。
美国、日本学者研发的光脉冲调制扫描隧道显微镜和德国雷根斯堡大学等研制的太赫兹扫描隧道显微镜都成功实现高时间分辨隧穿电流的测量和高空间分辨率动力学信息的获取[18,19]。图5所示
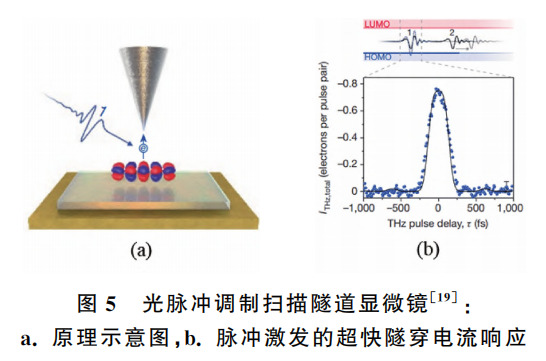
为太赫兹扫描隧道显微镜,通过将光泵浦脉冲与扫描隧道显微镜结合,能够同时实现原子级的空间分辨能力与飞秒级的时间分辨能力。美国加州大学集成的超快原子力显微镜可实现多种半导体材料超快电子动力学的探测[2023]。
阿秒脉冲和阿秒瞬态谱学技术促进了对价电子和内壳层电子的更进一步研究,电子动力学过程包括其激发、电离和跃迁过程都能实现精确测量[24]。德国慕尼黑工业大学[25]通过具有阿秒分辨率的超快吸收光谱成像,揭示了中间电子态在多电荷离子形成中的作用。中国西北核技术研究所对CO分子阿秒瞬态吸收中的多电子效应进行了理论推导[26],并利用超快激光实时探测与操控单个原子分子量子态,包括产生和操控原子内壳层的空穴态[27,28]。德国马克斯—普朗克研究所[29]结合扫描隧道显微镜和阿秒技术,在埃米级空间和亚飞秒时间分辨率下直接可视化分子中的量子电子相干性。

原子制造过程的观测同时追求空间和时间分辨率,具有窄脉宽、低能散和低发散角的超快相干电子源是关键。国家纳米中心通过碳纳米管替代金属纳米针尖,利用可见波段激光实现了光场电子发射,并获得了能量散度最低为0.25eV 飞秒电子发射,满足了原子级分辨对电子束 能量散度的要求[30,31]。该团队还发现采用半导体性的碳纳米管可以实现40阶的极端非线性光电子发射,并实现了调制深度达100%且时间精度达到40阿秒的载波包络相位调制效应[32]。除了基于扫描探针的观测之外,德国康斯坦茨大学使用连续波激光器的光学周期将透射电子显微镜内的电子束分散成短于半个光周期的电子脉冲,用于在原子和光周期的尺度上可视化光—物质相互作用[33]。近日该课题组结合透射电子显微镜与阿秒激光技术,将光学响应观测推进到阿秒时间分辨率,对在超高时空维度上理解光—物质相互作用具有很高价值[34]。
2023年,诺贝尔物理学奖颁发给了美国哥伦布俄亥俄州立大学 Pierre Agostini、德国加兴马克斯普朗克量子光学研究所 Ferenc Krausz和瑞典隆德大学 Anne L’Huillier,以表彰他们“开发阿秒光脉冲实验方法来研究物质中的电子动力学”,这些研究成果为人类提供了探索原子和分子内部电子世界的新工具。目前,超快科技结合高空间分辨率测量技术在电子、晶格动力学研究中发挥着不可替代的作用。而原子级制造过程涉及的复杂对象、极端尺度、过程复杂不可重复、多元参量使得超快观测的难度不断提升,呈现两个发展趋势:从单一尺度向多尺度转变,发展多系统协同全时空演化的跨尺度观测对揭示原子级制造过程中电子、原子动态演化复杂机理意义重大;一次一帧的“超快照相”向一次多帧的高灵敏度“超快摄像”跨越,对于揭示原子级制造过程中不可重复的量子效应等新现象具有不可替代的优势;单一维度观测向多维度、多参数在线实时观测拓展,如何结合多物理场模式,实现跨尺度的多维、多参数测量至关重要。为此,亟需攻克超高时—空分辨率协同、超快连续观测、高灵敏度微弱信号探测、多频多维信息获取、多系统协同耦合以及极端时空条件下力、热、电、磁等多场耦合环境的精确感知与观测等挑战。
2.2 原子级制造的可控性保障:原子结构演变原位表征
材料在热、电、能量束等激励以及不同环境下的结构演变将直接决定原子尺度制造的可控性和精准性,建立原子尺度结构演变动态表征平台,准确理解原子尺度结构演变机理是保障原子级制造可控性的重要环节。透射电子显微镜是目前能实现原子级表征的设备之一,随着原位技术的发展,力、电、光、热等外场激励以及气体、液体等环境可引入至透射电子显微镜并加载至纳米单体上[35],可实现制造过程的动态表征,在原子尺度揭示材料在不同激励及环境作用下的演变机制,继而发展原子尺度制造的新原理和新工艺。
在透射电镜中,电子束不仅可以用于成像,还可以用于原子精度的结构调控及加工,并实现结构演变的动态观察。国内外多个研究团队利用透射电子显微镜研究了电子束辐照效应及其对材料结构的调控机制,为其在原子级制造方面的应用提供了基础[35]。美国麻省理工学院和奥地利维也纳大学的联合研究团队[36]实现了电子束辐照诱导的单原子操控;东南大学研究团队[37-39]原位观察了电子辐照 诱导的亚纳米一维结构形成、纳米结构的原子刻蚀及修复,阐明了结构演变机制,提出了基于电子束辐照的原子结构加工策略。如图7所示,
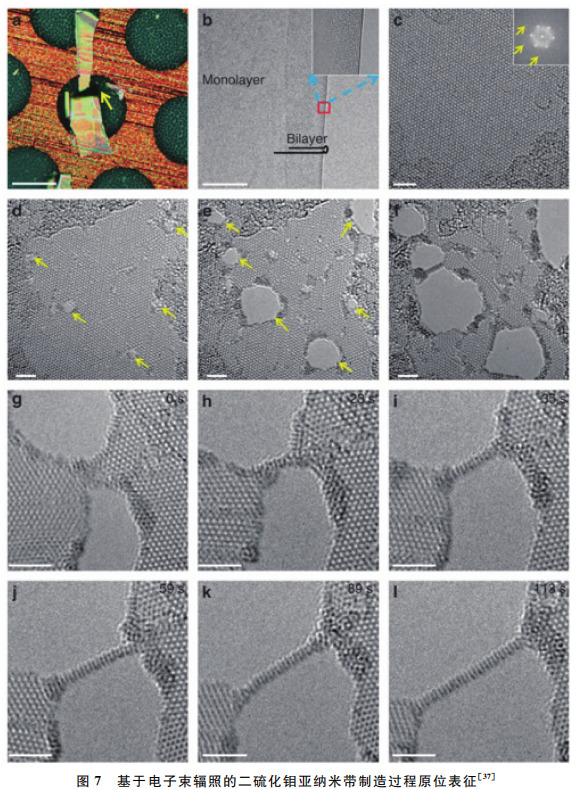
以电子束辐照在片状二硫化钼上制造出了均匀的超细硫化钼原子线,宽度仅为0.35nm,该研究给出了一种自上而下制造原子级器件的可控制造路线。美国宾夕法尼亚大学研究团队[40]利用原位 TEM 技术实时观察并定量研究了机械力作用下表面磨损现象,揭示了界面接触应力与原子去除速率的关联机制。美国匹兹堡大学研究团队[41,42]观察到了材料表面加工过程中原子尺度界面结构的实时演变过程,同时实现了纳牛精度的力学测量,揭示了原子扩散在金属材料表面加工过程中的重要作用。北京工业大学和浙江大学的联合研究团队[43]发展了基于微机电系统 (Micro-Electro-Mechanical System, MEMS)的原子 分辨高温(1200 ℃)力学原位测量系统,为极端工况下的加工过程研究开创了条件。
美国匹兹堡大学研究团队[44]原位表征了纳秒电脉冲诱导的金属结构演变,实现了纳米尺度金属界面的构筑与调控。东南大学研究团队原位观察了电场作用下异质界面附近的阳离子交换过程[45]以及原子扩散过程[46],阐明了电场对这些过程的调控机制,提出了电场调控的异质结构构筑方法。
为了保证原子级分辨能力,透射电子显微镜表征时试样通常位于真空环境,往往不同于真实制造环境。美国劳伦斯伯克利国家实验室、厦门大学、中国科学院物理所等国内外多个研究团队发展了基于MEMS的气、液环境表征技术[35],原子尺度原位观察了液体环境中纳米晶的形核与生长[47],为纳米材料可控制造提供重要实验和理论基础;原位观察了纳米气泡对纳米粒子的加速刻蚀行为[48],从纳米尺度揭示了固—液—气反应的具体路径,为液相刻蚀加工调控提供实验和理论基础。如图8所示,
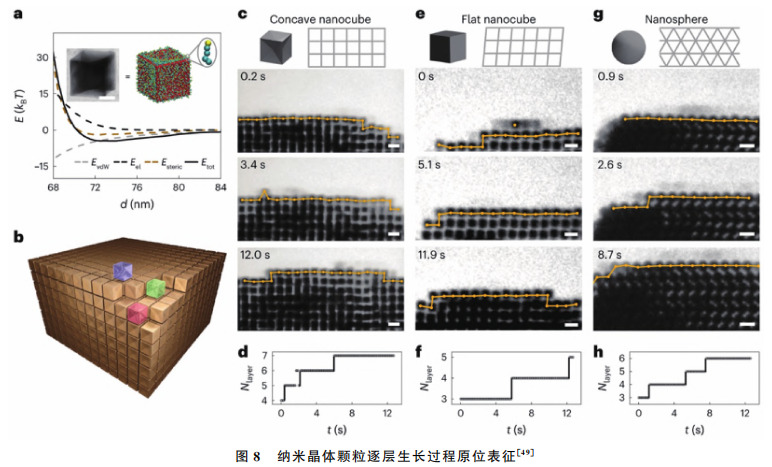
美国伊利诺伊大学团队[49]通过液相透射电子显微镜可观察到纳米颗粒晶体逐层生长的现象,并通过改变溶液条件和颗粒形状改变了生长方向,实现横向和纵向生长的可控转换,实现了原子尺度到微米尺度的跨越。
上述进展大部分是单一激励诱导的结构加工, 而原子级制造过程中,物质相互作用受到多物理场耦合作用的影响。基于透射电子显微镜的动态表征技术需进一步发展多场多环境耦合技术,实现不同原子级制造场景的原子结构动态表征和性能原位测量;进一步提升原位操控与测量的精度,发展整体测量与解耦技术,建立制造过程参量与产物性能的关系。
2.3 原子级制造的可靠性保障:制造过程质量监测
在原子级制造体系中,制造过程检测对于保障最终产品质量、分析缺陷和失效原因、优化制造过程以及深入理解制造机理都发挥着至关重要的作用。原子级制造过程中所出现的微小缺陷,如晶格缺陷、断裂、杂质等,可能导致器件或结构的整体性能下降、功能异常或可靠性降低。在制造过程的早期阶段准确地检测和识别这些缺陷并及时采取相应措施,对提高制造的品质和良率将发挥决定性作用,有利于保障原子级制造的可靠性。同时,原子级制造通常包含一系列复杂且精确的操作。制造过程检测能够实时监测和分析制造过程,提供待加工材料和 交互作用界面的关键信息,从而确定可调整的制造参数,深化对制造机理的认识[52]。
原子级制造涉及到原子之间(如原子间的化学键和物理力学效应等)以及原子与材料表面(如化学反应、扩散和吸附等现象)的多重交互作用[51-53],难以在关键参数和制造结果之间构建直接且准确的映射关系。因此,相较于纳米制造,在原子尺度上实现制造过程的品质调控更具复杂性和敏感性[54],这集中体现在以下几方面。首先,待加工材料存在的缺陷(如晶格缺陷、原子间位错等)和杂质更加难以表征,并且可能对最终器件或结构的功能特性及可靠性带来严重的影响。其次,环境因素(如温湿度)变化和外部扰动对制造过程的负面效应更加突出,导致所制造的器件或结构的一致性难以保证。最后,原子级制造过程的测量手段有限且存在较大的局限性,进一步增加了高水平品质调控的难度。从技术发展的角度看,原子级制造过程检测在继承了微纳制造对非结构化、多维度、跨尺度检测需求的基础上,发展出对原子级检测精度以及与制造过程相融性的新的迫切需求。
得益于轴向埃米级分辨率、非破坏、低成本的突出优势,原子力显微技术已成为原子尺度制造过程表征和测量的重要手段[55,56]。近年来,研究人员充分挖掘该方案通过力检测进行高分辨成像的优势, 实现了微观作用力检测条件下的原子级制造,将原子力显微镜拓展为集原子尺度加工和质量监测于一体的先进平台。如图9所示,
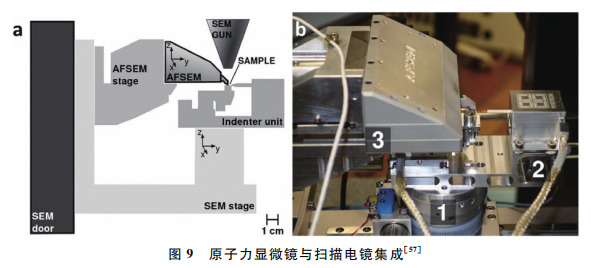
瑞士洛桑联邦理工学院Fantner团队将原子力显微镜与扫描电镜进行了集成,实现了真空条件下纳米压印等多种过程的原位测量[57,58],仪器在高度方向能够准确分辨出埃米级台阶[59]。德国伊尔梅瑙工业大学 Rangelow 团队设计了具有六自由度的原子力显微测量装备[60],搭建了与高分辨电子束光刻协同操作的集成系统,实现了对横向纳米级、轴向近原子尺度精细结构的制造过程控制[61,62]。在基于探针的原子级结构加工方面,日本丰桥工业大学团队[63]采用具有催化活性的镀铂原子力显微探针进行了硅基材料的局部化学蚀刻,加工出深度小于0.1nm 的凹槽机构,并给出了原子级结构的精确表征结果。然而,传统的原子力显微技术受限于成像范围与速度,难以应用于加工制造过程的在线监测。对于此,高速原子力显微镜是一种有效的解决方案。高速原子力显微具有高带宽、高响应的特点,能够实现毫米级范围的高分辨测量,有望应用于原子级制造过程的在线监测。德国国家计量研究所的团队[64]开发的高速大范围原子力显微镜(Atomic Force Microscope, AFM)实现了精度低于±0.7nm 的台阶高度测量,以及高达1mm/s的高扫描速度。Klapetek等人[65]将基于干涉仪的大面积XYZ定位台与高速原子力显微镜XY扫描仪相结合,开发了大面积高速原子力显微镜系统(图 10),在毫米扫描范围内实现了纳米分辨率。
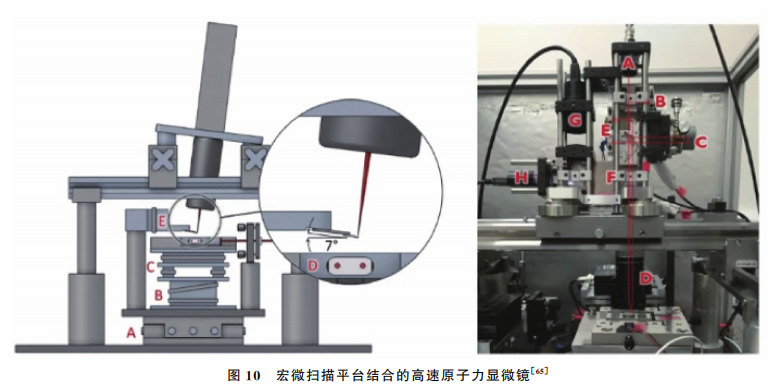
波士顿大学 KeithA.Brown课题组[66]通过结合无悬臂探针架构和用于检测探针—样品接触的可扩展光学方法,设计了新颖的大规模并行AFM (图11)。
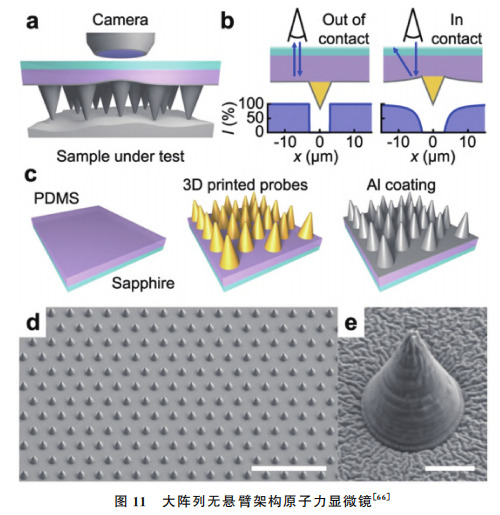
他们并行使用了 1088 个探头,能够以纳米级分辨率对5mm 宽的表面进行成像。结合高速扫描技术与大阵列扫描技术能够在保障原子级分辨率的基础上实现大通量、高效率的测量,是未来实现原子级制造质量监测的有效手段。
另一方面,在美国能源部的持续支持下,美国Zyvex Labs公司联合德克萨斯大学达拉斯分校 Reza Moheimani教授课题组在基于扫描隧道显微镜的氢去钝化光刻领域开展了一系列研究[67-69]。氢去钝化光刻是电子束刻蚀技术在原子尺度的延伸, 通过在隧道电场的作用下选择性解离材料表面的氢原子来诱发化学反应,进而实现原子级二维图形和三维结构的制造[70],图12
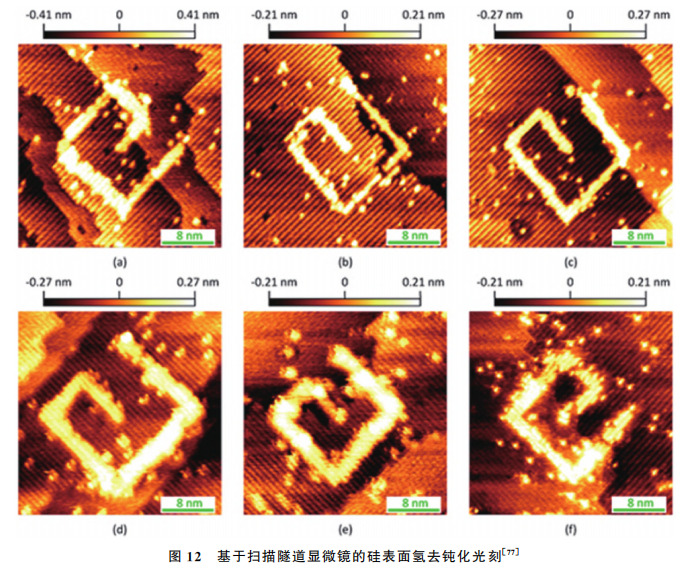
为氢去钝化光刻后的硅表面,最小刻蚀线宽仅为0.768nm,远小于目前的极紫外光刻线宽。然而,制造过程中探针针尖与材料表面间埃米级的间距极易导致扫描过程中发生碰撞,对器件造成不可逆的破坏。为了保障原子级制造过程的可靠性,需要制造过程的在线质量监测技
术,Reza Moheimani课题组[71,72]提出了基于高频信号注入的氢去钝化光刻新方法,将氢去钝化光刻过程与测量过程中针尖与样品的最小间距统一起来,利用滤波器将加工电流与检测电流分离,实现了制造过程中同时监测隧穿电流变化、原子级表面形貌,实现了制造与质量监测的一体化。然而,目前测量氢去钝化光刻仍然面临着效率低、加工范围小的难题,限制了其光 刻产物的进一步应用。目前美国Z yv ex Labs 公司拟定采用MEMS工艺制造多探头针协同、结合高速纳米定位台提高其加工、测量效率,以期望将该技术应用于生产原子级的电子电路器件。
为了加速高密度存储器件的原子尺度制造,荷兰代尔夫特理工大学[73]和加拿大阿尔伯塔大学[74]的研究人员分别提出了自动化氢去钝化光刻方案。尽管技术路线存在差异,但核心理念却非常相似:在制造过程中通过反复扫描成像准确辨识出悬空键结构的空间位置与分布,进而规划探针的操作路径,实现对光刻过程的快速、精准控制[75]。由此实现了强鲁棒、可修正的大规模原子精度数据存储,其存储能力可达21.4TB/cm 2,是现有硬盘存储能力的1000倍。
除此之外,随着半导体技术发展,芯片的特征尺寸越来越小,三维结构也越来越复杂,未来特征尺寸和结构将进一步达到原子尺度。需要发展非破坏、大范围、原子级精度的三维成像技术,满足未来原子级制造产品的尺寸检测以及缺陷检测,保障生产过程中的质量控制。
对于集成电路的无损检测,美国国家标准与技术研究院利用 X 射线的穿透性,采用临界尺寸小角度 X射线散射表征并测量Fin FET 晶体管的栅极间距、线宽等信息[76]。瑞士保罗·谢尔研究所基于瑞士同步辐射光源(Swiss-Light-Source,SLS)产生的X射线高度相干辐射获得了采用22nm 技术生产的IntelPentium G3260处理器芯片结构的叠层成像, 如图13所示,
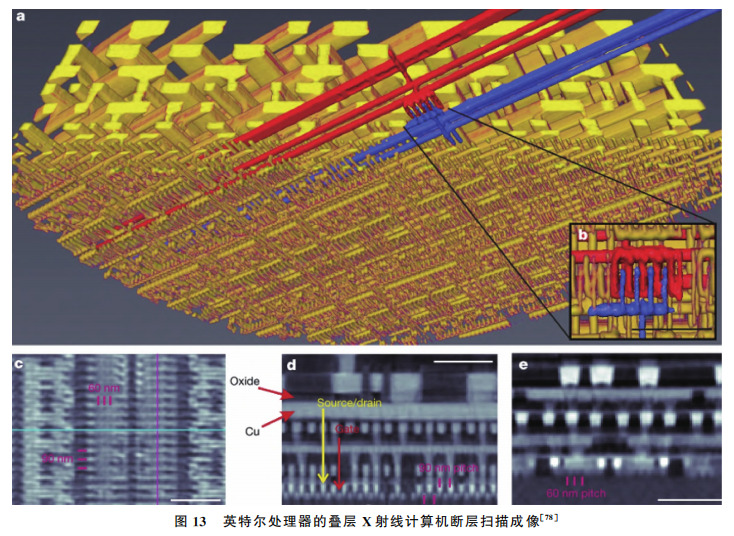
他们在直径10μm 的柱状范围内实现了14.6nm 结构分辨率的完整3D 成像,可以清楚地识别晶体管的栅极,测量获得节距、触点间距等结构信息[77]。华中科技大学刘世元团队[78]开发了高带宽、高分辨、高速穆勒矩阵椭偏仪,对二维材料光学和介电特性、有机材料复折射率与纳米膜厚、半导体纳米结构进行测量。该团队采用穆勒矩阵偏振测量法对光栅的结构、线粗糙度等参数进行测量,将测量提取到的参数值并与扫描电镜图像测得结果进行比较以表明该方法的正确性[79]。他们还提出将传统光学成像技术引入基于穆勒矩阵椭圆偏振测量的散射测量,开发了一种用于纳米结构计量的穆勒矩阵成像椭偏仪,实现了对光栅结构的高通量、低成 本、非破坏、高效率的测量与重建[80]。目前,这一类针对制造缺陷的无损检测技术分辨率仅达到纳米量级,若能结合电子散射测量技术,将该技术的检测分辨率进一步提高到原子尺度,该技术有望成为原子级制造的可靠保障。
3 总结与展望
综上所述,原子精度测量是支撑制造质量的基石,要想造得出,必先测得出,要想造得精,必先测得准。极端时空尺度下的超快动力学观测是探索原子级制造过程新原理不可或缺的手段,对阐明原子级制造的内在机理意义重大。超高精度表征和制造过程监测技术是保证原子级制造产品质量与性能的必要工具,是保障原子级制造可达性与可靠性的重要前提。目前,面向原子级制造的测量与表征研究尚处于初始阶段,面临以下几方面的挑战:
(1)如何发展兼具高时空高能量分辨的测量技术,实现原子级制造过程的实时监测。原子级制造涉及极限时空尺度下的物理和化学过程,例如化学键形成与断裂、原子扩散等动态行为,蕴含大量新原理与新机制,为了解释原子级制造的微观机制,实现原子级制造过程的精准调控,保障原子级制造精度, 亟需构建面向原子级制造的超高时空分辨测量表征能力,同时满足飞秒/亚埃米时空分辨的测量需求,全面揭示原子级制造过程中的复杂的动力学过程。
(2)如何突破测量分辨率与测量范围相互制约难题,实现从原子尺度到宏观尺度的跨尺度原子精度检测。原子级器件的行为与宏观器件存在明显差异,亟需研发跨尺度测量技术,建立原子尺度效应与器件宏观性能的关系,建立原子级制造产物的评测技术体系及检测标准。
(3)如何实现定制化工况环境下原子级制造过程的在线监测能力。原子级制造涉及多种工况(如液相、气相等),并与光电力磁等多物理参量耦合。同时,在原子级制造过程引入的缺陷、形位误差等将严重影响制造结构的性能,亟需发展在定制化工况下缺陷、面形、关键参量的高精度评测新方法,实现高效无损在线检测,保障原子级制造的工艺控制和良率管理。
(4)如何打破原子级制造检测设备的卡脖子难题,实现测量与表征设备的自主可控。原子级制造测量与表征的发展离不开仪器设备的支撑,目前我国高精度测量与表征所需的核心部件和关键设备几乎全部依赖进口,球差校正透射电镜等高端测量表征设备已对我国禁运,亟需系统部署核心测量装备的研制,构建拥有自主知识产权的测量与表征装备体系,支撑高端制造测量的国产替代。因此,需要建立具有原子分辨的多维度、跨尺度、在线测量系统,实现原子级制造过程中的动态演变过程的实时观测。结合时间与空间尺度上的高分辨测量、突破多尺度协同测量及多模态及形性多参数动态测量瓶颈。把握这些挑战背后的机遇,将进一步揭示原子尺度上丰富的信息,推动解决半导体、航空航天、量子计算等的发展步伐。
参 考 文 献
[17] Park HS, Kwon OH, Baskin JS, et al, Direct observation of martensitic phase-transformation dynamics in iron by 4D single-pulse electron microscopy.Nano Letters,2009,9(11):3954-3962.
[18]Yoshida S, Aizawa Y, Wang ZH, et al, Probing ultrafast spin dynamics with optical pumpprobe scanning tunnelling microscopy.Nature Nanotechnology,2014,9(8):588-593.
[19] Cocker TL, Peller D, Yu P, et al. Tracking the ultrafast motion of a single molecule by femtosecond orbital imaging,Nature,2016,539(7628):263-267.
[20] Hansma PK,Schitter G, Fantner GE, et al, High-speed atomic force microscopy.Science,2006,314(5799):601-602.
[21] Zuttion F,Colom A, Matile S, et al, High-speed atomic force micmscopy highlights new molecular mechanism of daptomycin action,Nature Communications,2020,11(1):6312.
[22] Kodera N, Yamamoto D, Ishikawa R, et al, Video imaging of walking myosin V by high-speed atomic force microscopy.Nature,2010,468(7320):72-76.
[23]Marchesi A,Umeda K,Komekawa T, et al, An ultra-wide scanner for large-area high-speed atomic force microscopy with megapixel resolution.Scientific Reports,2021,11:13003.
[24]0ssiander M, RiemensbergerJ, Neppl S, et al. Absolute timing of the photoelectric effect. Nature, 2018,561(7723):374-377.
[25]Hütten K,Mittermair M, Stock SO,et al. Ultrafast quantum control of ionization dynamics in krypton, Nature Communications,2018,9(1):719.
[26]Zhang B,Zhao J,Zhao ZX. Multi-electron effects in attosecond transient absorption of CO molecules. Chinese Physics Letters,2018,35(4):043201.
[27] Leone SR, McCurdy CW, Burgdörfer J, et al. What will it take to observe processes in ‘real time’? Nature Photonics.2014,8:162-166.
[28] Krausz F,Stockman Ml, Attosecond metrology: from electron capture to future signal processing.Nature Photonics,2014,8:205-213.
[29] Garg M,Martin-Jimenez A, Pisarra M,et al. Real-space subfemtosecond imaging of quantum electronic coherences in molecules, Nature Photonics,2022,16:196-202.
[30] Li C, Zhou X,Zhai F, et al. Carbon nanotubes as an ultrafast emitter with a narrow energy spread at optical frequency. Advanced Materials, 2017,29(30): 1701580.
[31] Li C, Zhou X, Zhai F, et al. Quiver-quenched optical-field-emission from carbon nanotubes, Applied Physics Letters.2017,111(13):133101.
[32] Li C, Chen K, Guan MX, et al, Extreme nonlinear strong-field photoemission from carbon nanotubes.Nature Communications,2019,10(1):4891.
[33] Ryabov A,Thurner JW, Nabben D, et al. Attosecond metrology in a continuous-beam transmission electron microscope. Science Advances,2020,6(46): eabb1393.
[34] Nabben D, Kuttruff J, Stolz L, et al, Attosecond electron microscopy of sub-cycle optical dynamics. Nature,2023.619(7968):63-67.
[35] Sun L,Xu T,Zhang Z.In-Situ Transmission Electron Microscopy. Singapore:Springer Nature Singapore, 2023.
[36] Su C, Tripathi M, Yan QB, et al. Engineering single-atom dynamics with electron irradiation. Science Advances, 2019.5(5): eaav2252.
[37] Liu XF, Xu T, Wu X,et al. Top-down fabrication of sub-nanometre semiconducting nanoribbons derived from molybdenum disulfide sheets. Nature Communications.2013,4:1776.
[38] Xu T,Zhou YL, Tan XD, et al.Creating the smallest BN nanotube from bilayer h-BN.Advanced Functional Materials,2017,27(19):1603897.
[39]Shen YT, Xu T, Tan XD, et al. In situ repair of 2D chalcogenides under electron beam irradiation. Advanced Materials, 2018,30(14): e1705954.
[40]Jacobs TDB, Carpick RW. Nanoscale wear as a stress-assisted chemical reaction, Nature Nanotechnology,2013,8(2):108-112.
[41] He Y, She DS, Liu ZY, et al. Atomistic observation on diffusion-mediated friction between single-asperity contacts.Nature Materials,2022,21(2):173-180.
[42] Wang X,Liu ZY, He Y, et al. Atomic-scale friction between single-asperity contacts unveiled through in situ transmission electron microscopy. Nature Nanotechnology.2022, 17(7):737-745.
[43] Zhang JF, Li YR, Li XC, et al. Timely and atomic-resolved high-temperature mechanical investigation of ductile fracture and atomistic mechanisms of tungsten.Nature Communications,2021,12(1):2218.
[44] Zhong L,Wang JW,Sheng HW,et al. Formation of monatomic metallic glasses through ultrafast liquid quenching. Nature,2014,512(7513):177-180.
[45] Zhang QB, Yin KB, Dong H,et al. Electrically driven cation exchange for in situ fabrication of individual nanostructures, Nature Communications,2017,8:14889.
[46] Zhang H,Xu T, Yu KH, et al. Tailoring atomic diffusion for in situ fabrication of different heterostructures. Nature Communications,2021,12(1):4812.
[47]Zhu C, Liang SX, Song EH,et al. In-situ liquid cell transmission electron microscopy investigation on oriented attachment of gold nanoparticles, Nature Communications,2018,9(1):421.
[48] Wang W, Xu T, Chen JG, et al. Solid-liquid-gas reaction accelerated by gas molecule tunnelling-like effect. Nature Materials,2022,21(8):859-863.
[49] Luo BB, Wang ZW, Curk T,et al. Unravelling crystal growth of nanoparticles, Nature Nanotechnology,2023,18(6):589-595.
[50] Fang FZ, Atomic and close-to-atomic scale manufacturing:perspectives and measures. International Journal of Extreme Manufacturing,2020,2(3):030201.
[51] Bothra P, Stieg AZ, Gimzewski JK, et al. Controlled vertical transfer of individual Au atoms using a surface supported carbon radical for atomically precise manufacturing.Precision Chemistry,2023,1(2):119-126.
[52] Hou X, Li JY, Li YZ, et al, Intermolecular and surface forces in atomic-scale manufacturing, International Journal of Extreme Manufacturing,2022,4(2):022002.
[53]Adams JB, Hector LG Jr, Siegel D], et al. Adhesion,lubrication and wear on the atomic scale. Surface and Interface Analysis,2001,31(7):619-626.
[54] Wyrick J, Wang XQ, Kashid RV, et al. Atom-by-atom fabrication of single and few dopant quantum devices.Advanced Functional Materials, 2019,29(52):1903475.
[55] Fang FZ,Zhang N, Guo DM, et al, Towards atomic and close-to-atomic scale manufacturing, International Journal of Extreme Manufacturing,2019,1(1):012001.
[56] An H], Wang JS, Fang FZ. Material removal on silicon towards atomic and close-to-atomic scale by infrared femtosecond laser, Materials Science in Semiconductor Processing,2023,158:107368.
[57] Kreith J, Strunz T, Fantner EJ, et al, A versatile atomic force microscope integrated with a scanning electron microscope. The Review of Scientific Instruments, 2017,88(5):053704.
[58]Andany SH,Hlawacek G,Hummel S, et al. An atomic force microscope integrated with a helium ion microscope for correlative nanoscale characterization. Beilstein Journal ofNanotechnology,2020,[59] Dukic M,Adams JD,Fantner GE. Piezoresistive AFM cantilevers surpassing standard optical beam deflection in low noise topography imaging.Scientific Reports, 2015,5:16393.
[60] Angelov T,Ahmad A, Guliyev E,et al. Six-axis AFM in SEM with self-sensing and self-transduced cantilever for high speed analysis and nanolithography. Journal of Vacuum Science & Technology B,2016,34(6):06KB01.
[61] Hofmann M,Mecholdt S,Mohr M,et al.Nanoscalelift-off process using field emission scanning probe lithography. Journal of Vacuum Science & Technology B,2019,37 (6):061803.
[62]Kaestner M,Rangelow IW, Scanning probe lithography on calixarene towards single-digit nanometer fabrication.International Journal of Extreme Manufacturing,2020,2(3):032005.
[63]Yamamoto K,Sato K, Sasano J, et al, Localized etching of silicon in water using a catalytically active platinum-coatedatomic force microscopy probe. Precision Engineering.2017,50:344-353.
[64] Dai GL, Zhu F, Fluegge J. High-speed metrological large range AFM, Measurement Science and Technology, 2015,26(9):095402.
[65] Klapetek P, Valtr M, Picco L, et al. Large area high-speedmetrology SPM system. Nanotechnology,2015,26(6):065501.
[66] Cao WH,Alsharif N, Huang ZJ, et al. Massively parallel cantilever-free force microscopy Nature Communications,2021,12(1):393.
[67] Randall JN,Owen JHG, Lake J, et al, Highly parallel scanning tunneling microscope based hydrogen depassivation lithography. Journal of Vacuum Science &. Technology B.2018,36(6):06JL05.).
[68] Alipour A, Fowler EL, Reza Moheimani SO,et al. Atomicresolution lithography with an on-chip scanning tunneling microscope. Journal of Vacuum Science &. Technology B,2022,40(3):030603.
[69] Alipour A, Reza Moheimani SO, Owen JHG, et al. Atomic precision imaging with an on-chip scanning tunneling microscope integrated into a commercial ultrahigh vacuum STM system. Journal of Vacuum Science &. Technology B,2021,39(4):040603.
[70] Ballard JB, Sisson TW, Owen JHG, et al. Multimode hydrogen depassivation lithography: a method for optimizing atomically precise write times, Journal of Vacuum Science &Technology B, 2013,31(6): 06FC01.
[71] Alemansour H, Reza Moheimani SO, Owen JHG, et al.Controlled removal of hydrogen atoms from H-terminated silicon surfaces, Journal of Vacuum Science &. Technology B,2020,38(4):040601.
[72] Alemansour H, Reza Moheimani SO, Owen JHG, et al.High signal-to-noise ratio differential conductance spectroscopy. Journal of Vacuum Science &. Technology B,2021,39(1):010601.
[73] Kalff FE, Rebergen MP, Fahrenfort E, et al. A kilobyterewritable atomic memory. Nature Nanotechnology, 2016.11:926-929.
[74] Achal R, Rashidi M, Croshaw J, et al. Lithography for robust and editable atomic-scale silicon devices and memories. Nature Communications,2018,9(1):2778.
[75] Celotta RJ, Balakirsky SB, Fein AP, et al. Invited Article: autonomous assembly of atomically perfect nanostructures using a scanning tunneling microscope. The Review of Scientific Instruments,2014,85(12): 121301.
[76] Kline RJ, Sunday DF, Windover D, et al. X-ray scattering critical dimensional metrology using a compact X-ray source for next generation semiconductor devices, Journal of Micro/Nanolithography, MEMS,and MOEMS,2017,16(1):014001.
[77] Holler M,Guizar-Sicairos M, Tsai EHR, et al. High-resolution non-destructive three-dimensional imaging of integrated circuits. Nature,2017,543:402-406.
[78] Chen XG, Gu HG, Liu JM, et al. Advanced Mueller matrix ellipsometry:Instrumentation and emerging applications.Science China Technological Sciences,2022,65(9):2007-2030.
[79] Liu SY, Chen XG, Zhang Cw. Development of a broadband Mueller matrix ellipsometer as a powerful tool for nanostructure metrology. Thin Solid Films, 2015,584:176-185.
[80] Liu SY, Du wC, Chen XG, et al. Mueller matrix imaging ellipsometry for nanostructure metrology, Optics Express,2015,23(13):17316.
Overview of the Current Research in Measurement and Characterization for Atomic Level Manufacturing
BingfengJu 1 Lan Jiang 2 Litao Sun 3 Yuanliu Chen 1 Jie Hu 2
Weina Han 2 Tao Xu 3 Dameng Liu 4 Chen Yang 5
Junhui Zhang 1,6 Jinyan Tang 1 Jingya Sun 2 Baoshan Guo 2
1.The State Key Laboratoryof Fluid Power 8. Mechatronic System, Zheiiang University,Hangzhou 3100272.
2.School of Mechanical Engineering, Beijing Institute of Technology, Beijing 100081
3.School of Electronic Science &. Engineering/School of Integrated Circuits, Southeast University, Nanjing 2111894.
4.State Key Laboratory of Tribology in Advanced Equipment, Tsinghua University, Beijing 1000845.
5.Hangzhou Global Scientific and Technological Innovation Center, Zhejiang University, Hangzhou 310058
6.Department of Engineering and Materials Sciences, National Natural Science Foundation of China, Beijing 100085
Abstraet Atomic level manufacturing refers to the advanced manufacturing technology that applies energyto atoms directly, achieving controlled removal of atomic level materials or largescale manipulation and assembly of atomic/molecular-level structures, This technology enables the leap in product performance and functionality, It is an advanced manufacturing technology that can be large-scale and mass-produced Atomic level manufacturing requires precise manipulation of atoms at a spatial scale of 10-10meters. The bonding time and electron dynamics changes of atoms during the manufacturing process occur in the range of femtosecond(10-15 seconds)to attosecond(10-18seconds). Therefore,it is required to measure andcharacterize the atomic level manufacturing process with ultrafast time and ultraspace resolution for accurately understanding and utilizing the new principles and effects at atomic scale, ensuring the accessibility and controllablility of atomic level manufacturing; Achieving high throughput and large-scale online monitoring of the atomic level manufacturing process is essential to ensure its reliability. Therefore.atomic level manufacturing measurement and characterization refer to the precise measurement and characterization of materials, structures, or devices at the atomic level in terms of time, space, and energy scales, This is crucial to guarantee the accessibility, controllability, and reliability of atomic level manufacturing. This article introduces the state of the art of measurement and characterization methods for atomic level manufacturing, summarizes three important points for future research: observation of atomic level ultrafast dynamic processes, in-situ characterization of atomic structure evolution, and online quality monitoring of atomic level manufacturing processes, Current challenges in measurement and characterization of atomic level manufacturing and suggestions for future development are also discussed in the article.
Keywords measuring and characterization for atomic level manufacturing;ultra high spatiotemporal resolution;dynamic characterization of atomic structure evolution;in-process measurement of atomic level manufacturing.
(责任编辑 刘 敏 张 强)
- 收藏




