用于 AR/VR 微显示器的钙钛矿颜色转换器图案化技术
Helio Display Materials, 英国牛津
颜色转换(Colour conversion, CC)是实现 AR/VR 高分辨率微显示器 RGB 色彩的最明确路径。当分辨率超过 5000 ppi(即 RGB 间距约为 5 µm)时,转换层的厚度对于效率和制造至关重要。钙钛矿凭借其对蓝光的高吸收系数(absorption coefficients),在性能上优于其他转换材料(如量子点或荧光粉)。
在本研究中,我们展示了如何通过图案化(patterned)工程化的、具有高光密度(optical density, OD)和高色彩纯度的钙钛矿材料来生产颜色转换像素。我们演示了三种图案化方法:剥离法(lift-off)、负性光刻胶法(negative photoresist)和干法刻蚀法(dry etch),并讨论了各自的优缺点。结果表明,钙钛矿材料具有稳健性,并能与多种适用于高分辨率微显示器的图案化策略兼容,巩固了其作为 AR/VR 应用首选材料的地位。
1. 引言 (Introduction)
MicroLED 是满足 AR 微显示器亮度要求的关键,但实现鲜艳的 RGB 色彩仍是一项重大技术挑战。颜色转换(CC)是目前实现这一目标最现实的方法。它结合了亮度、效率和色彩质量,且不会损害蓝色 MicroLED 发射器的性能。
微显示器对颜色转换材料的要求极其苛刻,但钙钛矿纳米晶(perovskite nanocrystals)能完美契合这些需求。除了高转换效率和卓越的蓝光吸收能力外,钙钛矿具有明确的化学定义,避免了量子点(QDs)中因纳米晶体尺寸变化导致的不一致性,且更容易在适宜的温度下制造。
MicroLED 显示器的一个核心特征是超高分辨率(5000 ppi 及以上)。在 5000 ppi(RGB 间距为 5.1 µm)下,亚像素尺寸需达到 。虽然目前已能有效制造该尺寸的氮化镓(GaN)基蓝色微型 LED,但这种像素尺寸对顶部沉积的颜色转换材料的吸收能力提出了严苛限制。
如果像素过厚,颜色转换像素容易出现机械不稳定(mechanical instability),并因光线主要从侧面溢出而导致显著损耗或串扰(cross-talk)。虽然可以通过围堰结构(bank structure)来缓解不稳定性,但已有研究表明,当展弦比(aspect ratio,注:亦称宽高比)增加时,吸收性围堰(absorptive banks)是主要的损耗机制。
因此,需要具有最高蓝光光密度的颜色转换材料。钙钛矿纳米晶凭借其内在的吸收特性在此领域表现优异。通过专有的合成方法和纳米晶表面定制,我们的红色和绿色像素均实现了 。据我们已知的信息来说,这比镉基(Cd-based)量子点的最佳报道高出约 2 倍,比磷化铟(InP)量子点高出 5 倍以上。这意味着在无需额外彩色滤光片的情况下,仅需 厚的像素即可实现高色彩质量(即极低的蓝光泄漏)。
本文讨论了基于钙钛矿纳米晶的 CC 像素的不同图案化方法,并评估了其在 AR/VR 微显示器中的应用潜力。在简要讨论了合成钙钛矿(perovskites)的特性之后 ,我们介绍了一种适用于薄像素(thin pixels)的剥离工艺(lift-off process) ;随后,我们展示了一种基于负载有钙钛矿纳米晶的负性光刻胶(negative photoresist)的传统光刻方法 ;最后介绍了一种干法刻蚀(dry etching)方案 。
2. 结果 (Results)
钙钛矿颜色转换材料
绿色和红色钙钛矿纳米晶体(perovskite nanocrystals)是采用专有合成路线和表面工程(surface engineering)合成的 ,并以高浓度()分散在甲苯(toluene)中 。图 1 展示了 (X = Br 和/或 I)薄膜的典型吸收和发射光谱 。与量子点(quantum dots)不同,钙钛矿的峰值波长主要由其化学成分决定,而非其尺寸(即处于弱量子局限机制,weak quantum confinement regime) 。对于红色钙钛矿,通过精细调节碘化物(iodide)与溴化物(bromide)的比例,可将发射峰调整至所需波长(此处为 623 nm) 。两种颜色均实现了窄发射峰(半高全宽 FWHM:绿色 20 nm,红色 32 nm),从而实现了超广色域(ultrawide colour gamut)。
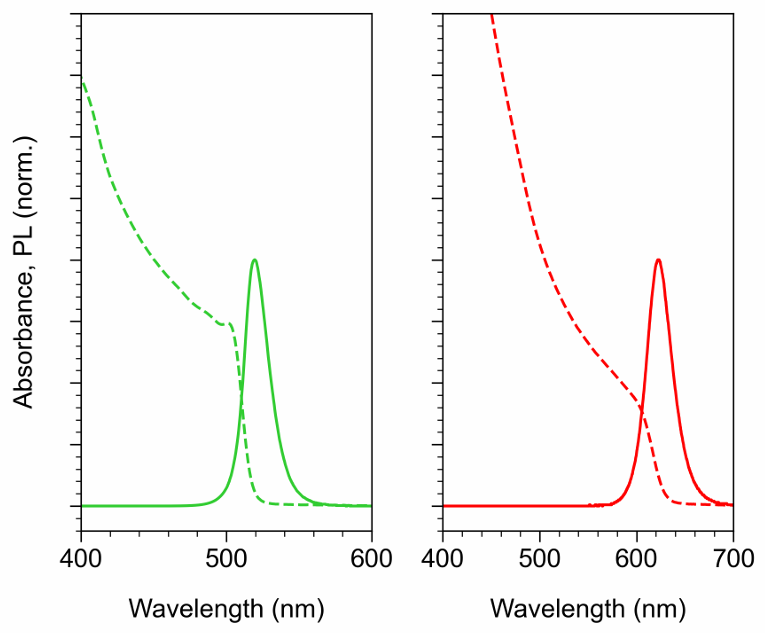
剥离工艺 (Lift-off process)
对于分辨率要求在 以下的 AR/VR 应用,通常不适合采用印刷方法。虽然诸如电流体动力打印(electrohydrodynamic printing)等先进方法可以达到所需的像素尺寸,但由于其串行打印工艺(sequential printing process)的特性,在加工耗时上存在很大的局限性。因此,我们主要关注适用于工业化生产、且在标准半导体晶圆厂(standard semiconductor fabs)中已有的微纳加工方法(microfabrication methods)。
我们演示的第一种方法基于剥离法(lift-off approach):在预先图案化的光刻胶(patterned photoresist)顶部均匀涂覆钙钛矿,随后将光刻胶剥离(见图 2a)。虽然这种方法能有效提供高分辨率,但寻找与颜色转换材料完全兼容的光刻胶可能具有挑战性。例如,光刻胶通常使用有机溶剂去除,而这些溶剂往往与分散钙钛矿纳米晶(perovskite nanocrystals)的溶剂相似,因此钙钛矿在步骤 2a 中可能会受损,或者在步骤 3a 中随光刻胶一同被去除(见图 2a)。
我们发现,使用基于氟化溶剂(fluorosolvents)和氟聚合物(fluoropolymers)的光刻胶系统(例如 Orthogonal 公司的 Oscor 4020 和 103 号显影液)可以实现剥离。在颜色转换材料未发生交联(cross-linking)的情况下,剥离工艺仅限于制造较薄的像素(约 ),这是因为小尺寸像素的机械强度(mechanical resistance)较弱,会导致其在剥离步骤中发生断裂。
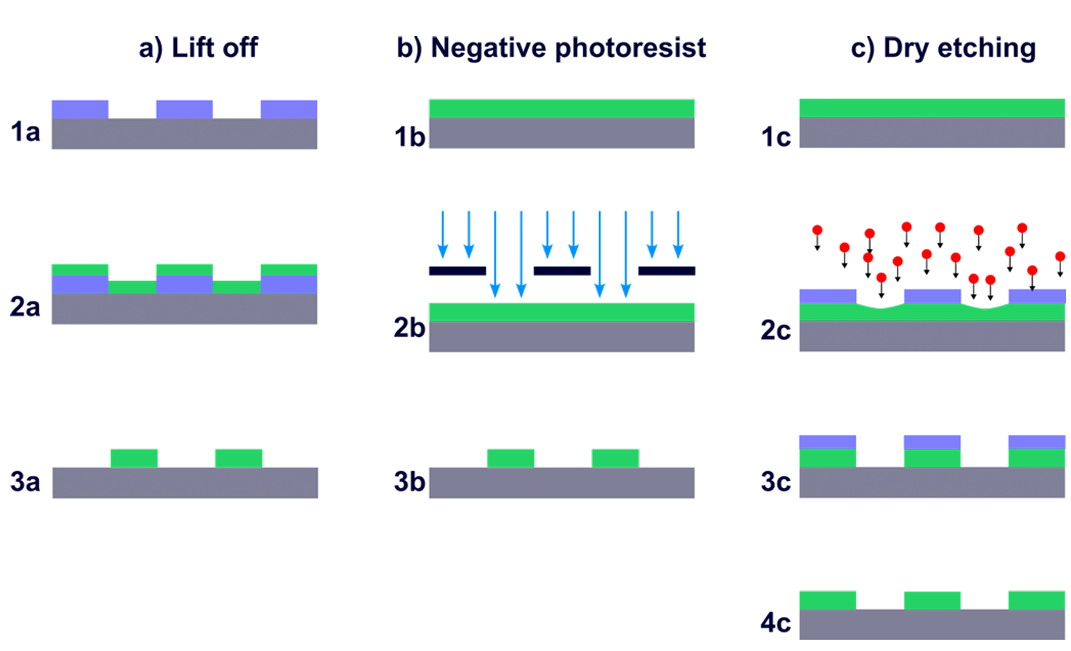
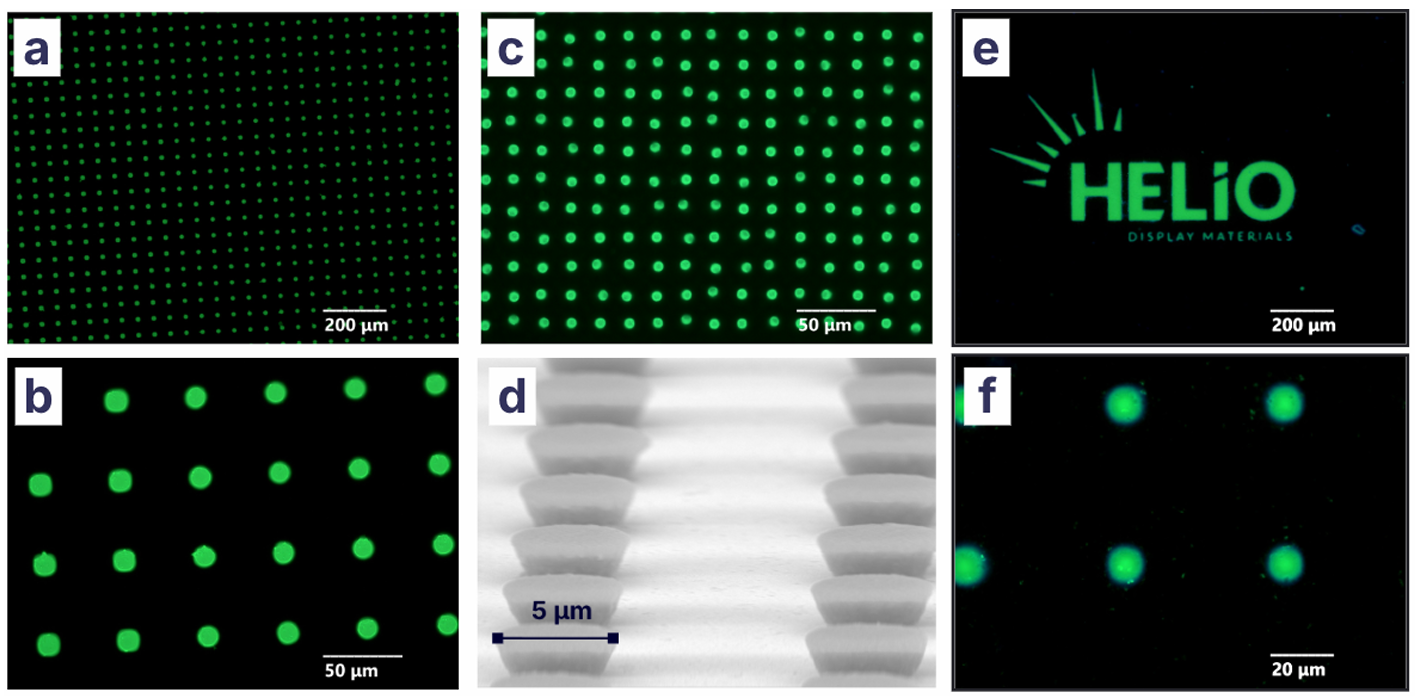
负性光刻胶 (Negative photoresist)
解决颜色转换像素机械稳定性的方案包括:纳米晶体(nanocrystals)之间的直接 UV 交联,或将纳米晶体嵌入 UV 固化树脂中。换言之,即配制成一种负性光刻胶。这种方法可用于增加剥离工艺中小型像素的厚度(图 2a)。然而,如果交联强度足够大,牺牲层光刻胶(sacrificial photoresist)将变得多余,从而可以采用更简便的光刻工艺(见图 2b 中的工艺)。
对于要求颜色转换像素在尽可能薄的同时最大程度减少蓝光泄漏(blue leakage)的 AR/VR 应用而言,负性光刻胶面临的关键挑战包括:i) 在可交联树脂中实现钙钛矿纳米晶的最大载量(loading);ii) 确保在这种高 UV 吸收材料内部实现充分交联。如果后者未能实现,像素将无法附着在表面,并在显影(development)过程中被冲走。
在本研究中,我们采取了多项措施组合来达成这些目标。首先,我们对钙钛矿纳米晶进行了工程化处理,使其表面具有可交联官能团(cross-linkable functional groups)。接着,我们开发了一种基于硫醇-烯化学(thiol-ene chemistry)的高灵敏度树脂配方,以在钙钛矿高载量下实现良好的交联。最后,我们选择了合适的光引发剂(photoinitiators)并优化了其浓度。例如,钛茂金属光引发剂(titanocene photoinitiators)因其高吸收系数和宽吸收光谱而表现得尤为高效。
在图 3c 和 3d 中,我们展示了使用含有钙钛矿的负性光刻胶配方所实现的图案示例。与剥离法不同,我们发现这种方法适用于更厚的像素,从而能够完全吸收蓝光。图 4 说明了单位像素厚度的光密度(OD/µm)权衡:绿色光刻胶的光密度比纯材料(不含树脂)降低了约 25%。我们注意到,由于钙钛矿极高的内在吸收(intrinsic absorption),这两种材料实现的 均显著优于量子点光刻胶(QDPR)。
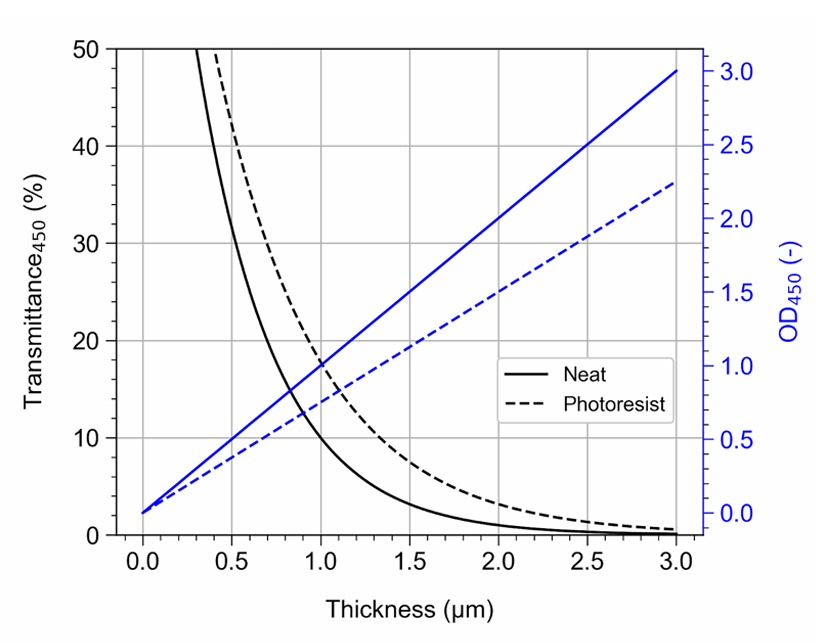
干法刻蚀 (Dry etching)
在半导体制造中,干法刻蚀是图案化硬材料和软材料的常用方法,但它仅偶尔被用于图案化颜色转换材料。考虑到工业设备的普及性,以及其在诸如微显示器前盖板(frontplane)等晶圆级衬底工艺中的可扩展性,这一点或许令人意外。一个显著的例外是关于中子探测器制备的报道 [5],该研究利用 HBr 和 Ar 等离子体组合来刻蚀用于中子探测器的。对于干法刻蚀工艺而言,刻蚀掩模(etch mask)是一个关键组件,它应当与待刻蚀材料具有良好的工艺兼容性,并提供良好的刻蚀速率对比度(etch rate contrast,即选择比)。在 Caraveo-Frescas 等人 [5] 的工艺中,他们使用了一种在加工过程中会被消耗的牺牲层铬(Cr)硬掩模(hard mask)。
为了刻蚀钙钛矿材料,我们发现 等离子体可以有效去除微米(µm)厚度的薄膜。我们选择了一种简化的工艺,使用厚光刻胶作为刻蚀掩模。与剥离工艺(lift-off)类似,我们发现可以在不损害材料的情况下,在钙钛矿顶部加工氟化光刻胶系统(Oscor 4020,显影液 103)。由于刻蚀速率对比度非常有限,钙钛矿与光刻胶之间的厚度比至关重要。通过优化条件,我们实现了绿色钙钛矿纯材料的均匀刻蚀且无残留(见图 3e-f)。由于刻蚀速率对比度较差,所得像素的厚度受到了限制。我们建议,使用硬掩模(如金属、氧化物或氮化物)将显著扩大工艺窗口,并在不损害横向尺寸(lateral dimensions)的情况下实现更厚的像素。
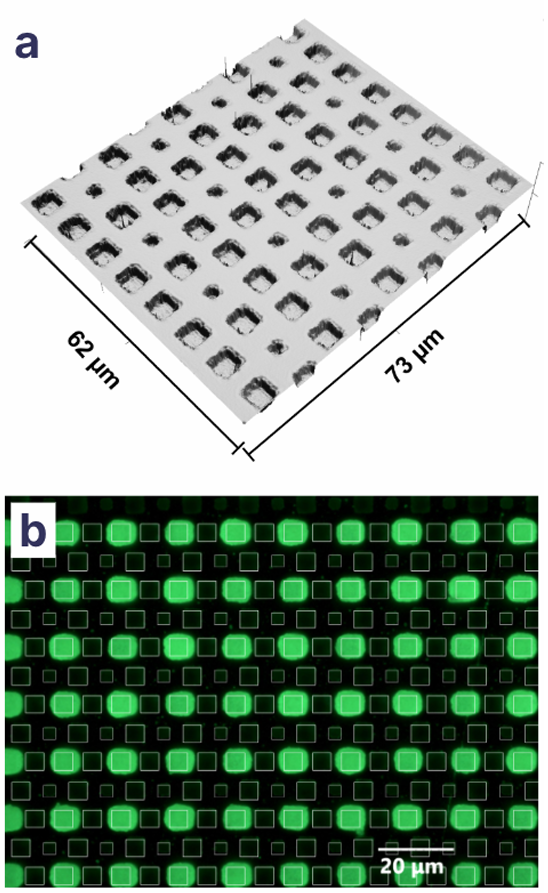
3. 讨论与结论 (DISCUSSION AND CONCLUSION)
在本研究中,我们展示了三种不同的图案化方法,这些方法均适用于制备尺寸符合 AR/VR 微显示器颜色转换要求的微小像素。我们将这些方法的各自优劣总结在表 1 中。总而言之,这些结果表明钙钛矿材料具有通用性和稳健性,可以被工程化加工成适用于各种方法的配方。
当需要交联(cross-linking)时,类似于 LCD 中彩色滤光片(colour filters)加工方案的负性光刻胶法(negative photoresist approach)是首选。然而,对于极小尺寸的像素,负性光刻胶常见的钻蚀(undercut)现象可能会限制像素的附着力。不过,通过使用主机矩阵(host matrix)可以缓解这一问题,同时还能进一步改善串扰(cross-talk)并提升效率。
表 1:本文所讨论的各种图案化方法(patterning methods)之优缺点
| 图形化方法 | 优点 (+) | 缺点 (-) |
|---|---|---|
| 剥离工艺(Lift-off) | • 高分辨率 • 无需交联 • 高单位厚度光密度 (OD/μm) | • 溶剂兼容性挑战(光刻胶 vs 钙钛矿) • 仅限于薄层加工 |
| 光刻胶法(Photoresist) | • 机械稳定性高(已交联) • 具有良好的可扩展性 | • 因交联剂/树脂导致 OD/μm 较低 • 钻蚀 (Undercut) 限制分辨率 • 长时间 UV 曝光导致材料损伤 |
| 干法刻蚀(Dry etch) | • 高分辨率 • 无需交联 • 高 OD/μm • 具有良好的可扩展性 | • 溶剂/光刻胶兼容性问题 • 刻蚀对比度(选择比)不足 • 刻蚀气体/等离子体损伤 • 过刻蚀 (Overetch) |
参考文献
- P. Palomaki, K. Twietmeyer, “26-3: Optical Modeling of Quantum Dot‐OLED (QD‐OLED) Color Conversion”, SID Symp. Dig. Tech. Pap., vol. 53(1), 303-306, 2022. [cite: 165, 166]
- C.J. Chena, K.A. Chenb, R.K Chianga. "12‐3: Materialization of Mid‐Resolution Quantum Dot Color Converters on G2. 5 TFT‐LCD Production Line for Micro‐LED Displays." SID Symp. Dig. Tech. Pap., vol. 55(1), pp. 128-131. 2024 [cite: 167, 168]
- I. Jen-La Plante et al., "55‐2: quantum dot color conversion for displays." SID Symp. Dig. Tech. Pap., vol. 54(1), pp. 792-794. 2023. [cite: 168, 169]
- Y. Kambe et al., "67‐1: High Optical Density, High Efficiency Quantum Dot Photoresist for MicroLED Applications." SID Symp. Dig. Tech. Pap., vol. 56(1), pp. 907-909. 2025. [cite: 170, 171]
- J.A, Caraveo‐Frescas, M.G. Reyes‐Banda, L. Fernandez‐Izquierdo, M.A Quevedo‐Lopez, “3D microstructured inorganic perovskite materials for thermal neutron detection”, Adv. Mater. Tech., 7(6), p.2100956, 2022 [cite: 172, 173]
著录信息
- Ruairi Baker, Maria Pervez, Angus Hawkey, Nobuya Sakai, Valérie Berryman-Bousquet, and Bernard Wenger "Patterning perovskite colour converters for AR/VR microdisplays", Proc. SPIE 13821, Optical Architectures for Displays and Sensing in Augmented, Virtual, and Mixed Reality (AR, VR, MR) VII, 138210Z (5 March 2026); https://doi.org/10.1117/12.3079805
本站声明:本文转载自SPIE. DIGITAL LIBRARY,原标题为《DUAL-SIDE NIL: ANGULAR ALIGNMENT ACCURACY AND FIRST-SIDE PROTECTION FOR AR APPLICATIONS》。文章版权归原作者及原载媒体所有。本平台转载仅供微纳制造与半导体领域同行进行技术交流与学术探讨,不代表本平台赞同其观点或证实其内容的真实性。文中涉及的技术参数、工艺流程及行业预测仅供参考。鉴于微纳技术迭代迅速,请读者在实际科研或生产中以最新行业标准及实验数据为准。本平台不承担因使用本文内容而产生的任何直接或间接损失。如原作者认为转载行为不妥或涉及版权争议,请及时联系后台,我们将于 24 小时内删除处理。
- 收藏




