先进封装技术如何重塑检测格局
随着半导体器件持续向更复杂的封装方案演进,传统光学检测技术正触及物理和计算的边界。
业界日益依赖2.5D和3D集成、混合键合(hybrid bonding)以及晶圆级(wafer-level)工艺,这使得在保护良率的前提下,足够早且一致地检测缺陷变得困难得多。虽然光学检测在工艺控制中仍处于核心地位,但其发展方式正在挑战关于其应用范围和应用方式的固有认知。
多年来,光学检测的方法遵循着一个可预测的模式——即不断提升灵敏度和分辨率以跟上不断缩小的几何尺寸。这些努力带来了可衡量的进步,但也引入了远超简单尺寸缩放挑战的新难题。
“当特征尺寸缩小一半时,传感器需要四倍的像素数量才能在相同分辨率下覆盖相同的面积,”诺信测试与检测(Nordson Test & Inspection)研发总监John Hoffman表示,“这种缩放给相机技术和数据处理带来了持续的压力。”
此外,向3D-IC和其他先进封装的转变,带来了传统方法未曾设计应对的检测场景。高分辨率光学器件和先进照明常常会产生海量的干扰性误报(nuisance counts),而更薄的晶圆和更高的堆叠则导致翘曲(warpage)和景深(depth-of-focus)问题,从而破坏测量的稳定性。
“在先进封装中,挑战不仅仅是分辨率问题,” Onto Innovation公司检测产品营销负责人Damon Tsai说,“当多个芯片堆叠在一起时,真正的问题有时是你能否看清相关结构。”
这些限制迫使许多检测工作流程重新思考工装夹具(handling and fixturing)问题。设备供应商和研究机构已转向多通道照明、红外和基于激光的传感,以及更先进的信号处理技术,以应对下一代器件在可视性和测量方面的挑战。
从分辨率到可用性
在过去的二十年里,光学检测的改进主要集中在捕捉越来越精细的细节上。随着制程节点缩小、特征尺寸逼近个位数微米,投资重点集中在提高横向分辨率、缩小像素尺寸和扩展景深上。人们曾认为更好的光学器件和更精确的照明自然会带来更好的缺陷检测和更高的良率。在许多方面,这种方法确实奏效了。灵敏度阈值显著提升,光学系统能够更可靠地测量更小的特征。
然而,向3D集成、混合键合和晶圆级工艺的转变揭示了一个更复杂的现实。在这些环境中,仅仅看清更小的细节往往是不够的。高分辨率光学器件可能会放大不相关的背景纹理,或突显那些在功能上并不重要的干扰颗粒。当器件堆叠高达12层或更多层,或者当重布线层(redistribution layers)变得更加复杂时,光学检测系统每片晶圆可能返回数万个潜在缺陷信号。审查、分类和筛选如此大量的数据会拖慢生产速度,并削弱先进封装本应带来的生产力提升。
“在许多情况下,最大化灵敏度也会放大背景噪声并增加干扰性误报的数量,” Tsai说,“这种权衡使得过滤和分类策略变得更加重要。”
即使光学清晰度有所提升,可用性也取决于数据解读的效率。问题不仅在于收集更多图像或更高分辨率的扫描,还在于决定哪些信息与工艺控制相关,哪些信号可以忽略。随着检测系统生成更大的数据集,负担从单纯的检测转向了分类和相关性分析。
“每个芯片内部都有数百万个数据点,” PDF Solutions公司解决方案架构高级总监Marc Jacobs说,“当你以个性化方式分析检测数据时,你不仅仅是应用限制值。你是在将期望值与实际测量值进行比较。这才是提高异常检测能力的方法。”
业界日益依赖人工智能(AI)和机器学习(ML)正是对此问题的回应。但仅靠AI并不能解决根本挑战,即检测阈值和检测策略必须针对不同的封装场景进行调整。在扇出型(fan-out)晶圆中关键性的缺陷,在密度较低的组装体中可能是可接受的,反之亦然。这些背景因素通常需要工艺工程师和检测团队之间更紧密的协作,以定义何为限制良率的缺陷。对于许多制造商而言,这种从追求最高分辨率到追求最高可用性的转变,已成为检测策略的关键考验。
翘曲、薄晶圆与混合键合的挑战
向更薄基板和更高器件堆叠的转变,带来了一系列机械方面的挑战,使得光学检测变得复杂,这是前端工艺很少遇到的。在先进封装中,翘曲不再是偶尔的麻烦,而是一个持续存在的因素,它会扭曲测量结果、遮蔽特征,并导致不同晶圆间的再现性问题。随着封装密度增加以及器件向2.5D和3D形态迁移,晶圆或面板的机械稳定性变得与检测工具本身的光学性能同等重要。
检测这些薄且通常具有柔性的结构,需要将晶圆压平,或者动态调整光学器件以补偿不平坦的地形。两种策略都存在权衡。压平可能会产生机械应力或导致破裂,而动态聚焦跟踪则需要复杂的传感和控制回路,这会降低吞吐量或影响测量一致性。在某些情况下,唯一的可行方案是将更好的机械夹具与先进的图像校正算法相结合,以稳定数据采集。
“随着封装结构变得更加复杂,仅仅聚焦和测量已经不够了,”布鲁克(Bruker)公司应用开发负责人Samuel Lesko说,“你需要尽可能消除翘曲,创建一个可重复保持平整的参考状态,否则计量结果将失去意义。”
工程师们已尝试使用新材料和真空吸盘(vacuum chuck)设计来改善处理。这些机械上的适应通常是抵抗形变的第一道防线,尤其是在晶圆变得更薄、更容易在自身重量下弯曲的情况下。均匀的支撑表面可以减少导致测量误差甚至破裂的局部应力点。但即使经过精心设计,翘曲仍然是一个移动的目标,需要持续监控和补偿。
“翘曲是个问题,我们必须能够追踪它,” Hoffman说,“这通常意味着使用某种外部粗略估计传感器来测量表面如何变形,然后调整传感器的位置以便进行测量。”
例如,陶瓷真空吸盘可以更均匀地将压力分布在薄基板上,减少局部变形。但即使采用精密的夹具,单颗芯片范围内的晶圆翘曲也可能超过100微米,这远远超出了大多数传统光学系统的景深范围。其结果就是频繁失焦、模糊的测量边缘以及不可靠的套刻(overlay)数据。
将光学信号与物镜的限制解耦已成为一个活跃的研究领域。诸如白光干涉测量法(white-light interferometry)等技术正在被开发,以帮助即使在表面不平整或倾斜时也能保持垂直分辨率。这些技术可以通过将形貌信息与焦点变化分离来补偿某些类型的畸变。然而,它们仍然依赖于可预测的基线形状和已知的边界条件来产生一致的结果。
“白光干涉测量法将景深缩小到2微米以下,与光学放大倍率无关,即使表面透明、不平整或翘曲也能保持垂直分辨率,” Lesko说,“这种分离正是系统区分真实形貌与光学伪影的关键所在。”
混合键合则引入了另一层复杂性。与传统的焊料凸块(solder bumps)或微凸块(microbumps)不同,混合键合界面可能隐藏着空洞(voids)和未键合(disbonds)区域,这些缺陷仅靠光学技术难以检测。这些空洞可能只有几纳米深,但它们可能导致电气不连续性或长期可靠性故障。在某些情况下,光学检测会与声学方法或原子力显微镜(atomic force microscopy)相结合以验证键合质量。对纳米级表征的需求促使设备制造商探索混合计量(hybrid metrology)策略,将多种传感模式集成到单一平台中。
“随着键合节距(bonding pitches)缩小且界面需要纳米级表征,运用原子力显微镜和光学轮廓测量(optical profiling)变得更加重要,” Lesko说,“整合来自两种技术的信息,使你能够筛查缺陷,并获得关于缺陷焊盘(defective pad)和界面质量的详细信息。”
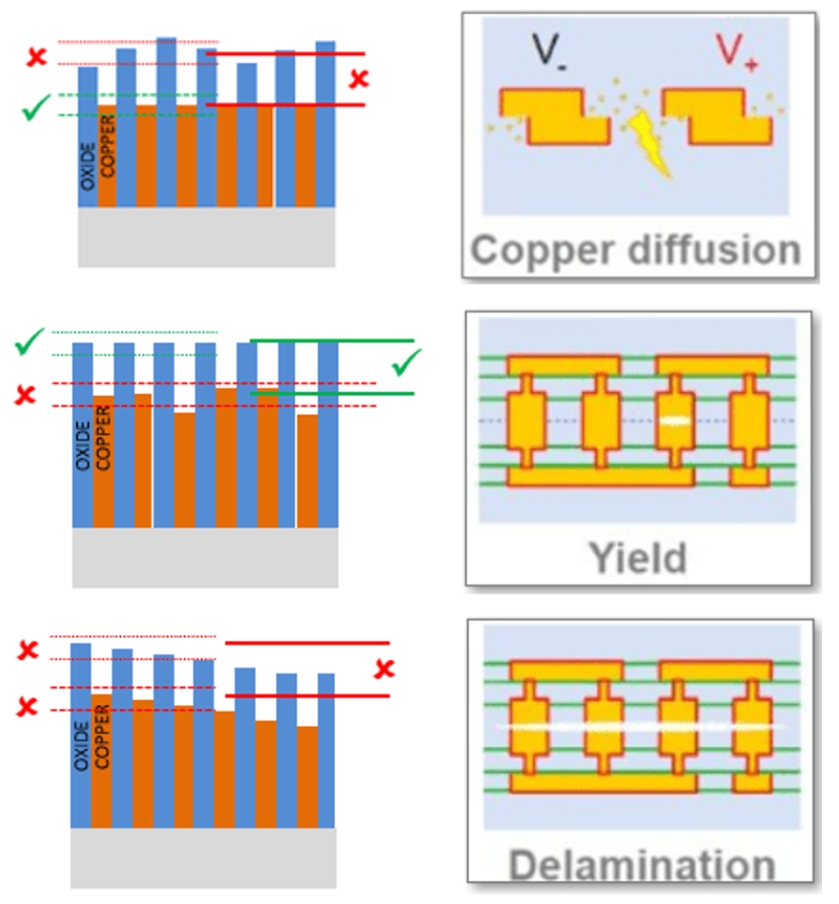
图1:混合键合的常见工艺缺陷。来源:Onto Innovation
在物理平整度、光学清晰度和混合键合验证之间取得平衡,这仍然是先进封装检测中最持久的挑战之一。即使在夹具、信号处理和多模态传感方面取得渐进式的改进,也能对良率和可靠性产生可衡量的影响,这就是为什么现在如此多的开发工作不仅关注提高分辨率,也同样关注稳定测量环境。
多重照明与多通道方法
随着检测挑战的增加,依赖单一光源已被证明不足以应对许多先进封装工艺。传统的明场(brightfield)或暗场(darkfield)照明通常难以区分多层堆叠中的污染物、结构缺陷和背景粗糙度。其结果可能是检测不一致或高假阳性率,特别是当工艺引入了有机残留物、薄膜空洞和变化的表面反射率的混合物时。
为了解决这个问题,设备制造商转向了多通道照明策略,结合不同的波长、角度和偏振状态。红外成像已变得更加普遍,因为它可以穿透硅以显示埋入式界面,尽管在涉及金属时它仍有局限性。基于激光的照明已成为另一个选项,用于突显那些在纹理化背景下本会融为一体的残留物。例如,在铜对铜(copper-to-copper)键合过程中留下的某些有机薄膜,在传统照明下可能不可见,但使用旨在增加对比度的窄带激光源时则变得可检测。
“如果使用传统的明场照明,光线从顶部照射,你会看透一切,” Onto公司的Tsai说,“当你增加多角度照明时,可以减少前层噪声(pre-layer noise)并使特定特征凸显出来。”
除了波长,照明角度在减少干扰信号方面也起着关键作用。斜射或多角度照明可以抑制来自更深层的反射或增强特定表面的对比度。在实践中,这些配置通常需要仔细平衡,以避免引入伪影或降低测量一致性。不同的照明通道也需要与相应的检测光学器件和滤光片匹配,以保持足够的信号质量。
虽然硬件改进有助于扩展可成像的范围,但由此产生的数据集的复杂性也同样迅速增长。多通道检测每片晶圆产生的原始数据量通常是传统明场检测的数倍。这种额外的负担使得嵌入式信号处理和机器学习对于将关键缺陷特征与良性变化区分开来变得至关重要。
一个持续的争论是,增加更多的照明模式是否会带来收益递减。每增加一个通道都会增加成本、校准时间以及系统间结果不一致的风险。就目前而言,大多数从事混合键合和高密度封装的工程师都认为,多重照明模式已成为必需而非奢侈,即使其中的权衡取舍仍在探索中。
“一直存在着这样的张力:拥有一个能解决问题的算法,但需要太多的计算资源来大规模运行,” Nordson的Hoffman说,“照明方面也是如此:你增加的通道越多,就越需要考虑数据量和一致性的问题。”
AI与机器学习掌控全局
多通道检测的稳步兴起带来了一个新问题——远超任何人工团队在可行时间内能够审查的数据量。即使是灵敏度或照明复杂性的适度增加,也可能导致需要分类的原始图像和特征图数量级增长。因此,机器学习不再是一个专业化的附加功能。它已成为将高分辨率光学信号转化为可操作信息的不可或缺的机制。
AI在检测中的第一波浪潮主要集中在图像分类上,应用训练好的模型来识别已知缺陷类型并将其归类。这种方法有助于减少干扰性误报,并加速验证被标记特征是否真正与良率相关的过程。随着时间的推移,这些模型变得更加复杂,不仅学习缺陷的外观,还学习其在不同工艺步骤和材料堆叠中的行为方式。
“检测工作流程过去需要大量手动配方(recipe)设置和从CAD数据的转换,” 诺信公司研发副总裁Charlie Zhu说,“现在我们使用AI自动生成这些配方,这缩短了设置时间并减少了错误。”
越来越多的检测系统已不再采用在数据采集后进行处理的计算集群。相反,一些工具在本地嵌入AI模型,允许立即进行分类和过滤。这种硬件加速的方法可以通过消除将海量数据传输到外部服务器的延迟来提高吞吐量。然而,这也引发了透明度和可再现性的问题。神经网络以不透明著称,一些工程师仍然对依赖难以验证的决策逻辑感到担忧。
“在许多情况下,对于某些精确测量,传统算法仍然效果更好,因为它们以原生分辨率运行,” Zhu说,“深度学习模型通常会下采样然后重新缩放数据,这可能会损失一些位置精度。”
AI的另一个挑战是模型过拟合(overfitting)到特定产品类型或工艺条件的风险。当引入新材料或结构时,训练数据可能不再代表生产的可变性。
“没有一个单一模型能适用于所有地方,” Hoffman说,“即使你在大量数据上训练它,当产品组合发生变化或客户引入前所未见的东西时,它也可能漂移(drift)或过拟合。”
因此,许多公司采用了混合工作流程,将确定性算法(deterministic algorithms)与机器学习过滤器相结合。这种分层方法使团队能够在保留高置信度测量的同时,仍受益于AI标记意外异常或识别细微缺陷模式的能力。
尽管存在这些局限性,支持AI的检测已被证明在大批量先进封装环境中至关重要。仅靠传统的基于规则的逻辑,数据分类的速度和规模根本不可持续。大多数工程师预计,随着工艺的持续发展,确定性检测和数据驱动检测之间的平衡将仍然是一个移动的目标。
整合计量数据与工艺反馈
虽然光学和机器学习的改进扩展了可检测的范围,但在识别缺陷与理解其在特定环境中的含义之间仍然存在差距。仅凭检测数据并不总能揭示某个偏差是否会影响到器件可靠性,尤其是在工艺窗口频繁变化的高混合(high-mix)生产环境中。因此,公司已投入巨资将检测系统与工艺控制和设计数据连接起来,以构建更具预测性的良率模型。
“将AI直接嵌入检测工具内部,减少了将大型数据集传输到外部服务器进行分析的需求,” Tsai说,“这种方法有助于保持吞吐量,同时仍能提供足够的信息来反馈给工艺控制系统。”
传统上,检测输出被视为独立的记录,用于存档追溯或在回顾性失效分析中使用。如今,制造商越来越期望检测结果能直接反馈到闭环工艺调整中。通过将测量值与统计过程控制(SPC)模型和设计意图(design intent)进行比较,团队可以近乎实时地调整沉积速率、蚀刻轮廓或键合参数。在一些先进的工作流程中,检测数据还用于自适应配方生成(adaptive recipe generation),即根据最近的计量趋势动态计算新的工艺参数。
“机器学习已经发展到这样的程度,即使客户在工艺节点之间快速切换,模型也能传承早期设计的经验,” PDF的Jacobs说,“这有助于减少样本需求并缩短学习周期。”
“机器学习肯定有助于减少制造中的假警报数量,” Tignis公司营销副总裁David Park说,“你永远无法将它们降为零,但你可以显著减少在追踪无关紧要的事情上浪费的时间,并帮助人们更快地找到真正的根本原因。”
这种整合在先进封装中尤为重要,因为已知合格芯片(known good die)策略的成功依赖于对“合格”定义的及时更新。随着新材料的引入和互连几何结构的演变,基于旧工艺构建的参考库可能无法反映实际的变异性。因此,许多公司依赖混合方法,将确定性的SPC模型与适应细微工艺变化的持续学习系统结合起来。
将检测数据与设计信息联系起来也有助于改进采样策略。制造商可以根据仿真预测的高风险区域进行针对性检测,而不是随机或按固定间隔检测晶圆。这种选择性采样(selective sampling)方法在不牺牲灵敏度的情况下降低了检测开销。然而,它需要设计、计量和生产工作流的仔细协调,这一挑战使得许多组织难以完全自动化其反馈回路。
即使在该领域取得进展的公司中,关于数据治理和模型透明度的问题仍然存在。基于专有工艺信息训练的机器学习模型可能难以审计,而整合来自多个供应商的数据集会引入兼容性和安全性问题。对于大多数团队而言,实际的解决方案是构建模块化系统,允许确定性规则和机器学习输出共存,而不完全依赖其中任何一方。
结论:前路展望
随着先进封装技术的持续演进,光学检测很可能面临不断扩大的技术和操作挑战。新的工艺变体,如晶圆对晶圆混合键合(wafer-to-wafer hybrid bonding)、背面供电(backside power delivery)、双面加工(bi-facial processing)以及异质材料的集成,将把传统检测架构推向其当前极限。每一项创新都引入了更多的变异性,这些变异性可能掩盖缺陷,并对测量的再现性提出额外要求。向更薄基板和更高堆叠层数的推进只会加剧这些压力。
随着线宽缩小和互连密度增加,翘曲、表面变形和不一致的反射率预计将变得更难控制。与此同时,随着AI模型应用于更多样化的缺陷场景,制造商将需要清晰的验证和治理框架。当检测从单纯的识别走向预测性分析时,过拟合、漂移和缺乏透明度仍将是持续存在的风险。
尽管存在这些障碍,光学检测的未来很可能将由新机遇而非渐进式改进来定义。多通道成像、嵌入式机器学习以及与设计工作流更紧密集成的进步,正在将检测从一个静态的检查点转变为一个动态的良率优化工具。未来十年将较少关注孤立地看清尽可能小的特征,而更多关注连接不同的数据源,为整个工艺创建更清晰、更具可操作性的图景。
- 收藏




